一份针对 SJTU 微电子专业课程 MST3313 考试的知识总结。
Letter Unit Magnitude a atto 1 0 − 18 10^{-18} 1 0 − 18 f fempto 1 0 − 15 10^{-15} 1 0 − 15 p pico 1 0 − 12 10^{-12} 1 0 − 12 n nano 1 0 − 9 10^{-9} 1 0 − 9 u micro 1 0 − 6 10^{-6} 1 0 − 6 m milli 1 0 − 3 10^{-3} 1 0 − 3 k kilo 1 0 3 10^{3} 1 0 3 x mega 1 0 6 10^{6} 1 0 6 g giga 1 0 9 10^{9} 1 0 9
VTC (电压传输特性/DC传输特性)
V o u t V_{out} V o u t V i n V_{in} V in 门阈值电压/开关阈值电压 V M V_{M} V M V o u t = V i n V_{out}=V_{in} V o u t = V in
高逻辑电平/额定高电压 V O H V_{OH} V O H V O L V_{OL} V O L
可接受的高/低电压 V I H V_{IH} V I H V I L V_{IL} V I L V T C VTC V TC d V o u t d V i n \frac{dV_{out}}{dV_{in}} d V in d V o u t − 1 -1 − 1
噪声容限: N M L = V I L − V O L NM_{L}=V_{IL}-V_{OL} N M L = V I L − V O L N M H = V O H − V I H NM_{H}=V_{OH}-V_{IH} N M H = V O H − V I H
再生性:保证一个受干扰的信号经过若干逻辑级后收敛回额定电平中的某一个
图解法:
理论分析:
有一个增益绝对值大于 1 1 1 1 1 1
扇入和扇出
扇出:连接到驱动门输出端的负载门的数目 N N N
增大负载门 的输入电阻/减小驱动门 的输出电阻可以使这一影响减到最小
扇出大时,会使驱动门 的动态性能变差(因此器件定义了最大扇出)
扇入:门输入的数目。扇入较大的门比较复杂,会使得静态和动态特性变差
理想数字门(理想反相器模型)
g = ∞ g=\infty g = ∞ V M = V O H − V O L 2 = N M L = N M H V_{M}=\frac{{V_{OH}-V_{OL}}}{2}=NM_{L}=NM_{H} V M = 2 V O H − V O L = N M L = N M H R i n = ∞ R_{in}=\infty R in = ∞ R o u t = 0 R_{out}=0 R o u t = 0
性能
t p t_{p} t p
图:
t p L H t_{pLH} t p L H low to high output transition(50%→50%)t p H L t_{pHL} t p H L high to low output transitionPropagation delay time: t p d = m a x ( t p L H , t p H L ) t_{pd}=max(t_{pLH},t_{pHL}) t p d = ma x ( t p L H , t p H L )
Contamination delay time:t c d = m i n ( t p L H , t p H L ) t_{cd}=min(t_{pLH},t_{pHL}) t c d = min ( t p L H , t p H L )
t p = t p L H + t p H L 2 t_{p}=\frac{t_{pLH}+t_{pHL}}{2} t p = 2 t p L H + t p H L
fall & rise
图:
fall time 90% → 10%
risetime 10% → 90%
测量 t p t_{p} t p N N N N N N T = 2 × t p × N T=2\times t_{p}\times N T = 2 × t p × N t p t_{p} t p 2 N t p ≫ t f + t r 2Nt_{p}\gg t_{f}+t_{r} 2 N t p ≫ t f + t r
RC Network
charge V o u t ( t ) = V d d ( 1 − e − t / τ ) V_{out}(t)=V_{dd}(1-e^{ -t/\tau }) V o u t ( t ) = V dd ( 1 − e − t / τ )
到达 50% 点 : t = ln 2 τ = 0.69 τ t=\ln2\tau=0.69\tau t = ln 2 τ = 0.69 τ
10% → 90% :t = ln 9 τ = 2.2 τ t=\ln9 \tau=2.2\tau t = ln 9 τ = 2.2 τ
discharge V o u t ( t ) = V d d e − t / τ V_{out}(t)=V_{dd}e^{ -t/\tau } V o u t ( t ) = V dd e − t / τ
Power
功耗延迟积:P D P = P a v t p PDP=P_{av}t_{p} P D P = P a v t p
能量延迟积: E D P = P D P × t p EDP=PDP\times t_{p} E D P = P D P × t p
Chips Layout:
f f f λ = f 2 \lambda = \frac{f}{2} λ = 2 f
Yield and Cost
Die(晶粒)per wafer: π × ( w a f e r d i a m e t e r 2 ) 2 d i e a r e a − π × w a f e r d i a m e t e r 2 × d i e a r e a \frac{{\pi \times\left( \frac{{wafer\ diameter}}{2} \right)^2}}{die\ area}-\frac{{\pi \times{wafer\ diameter}}}{\sqrt{ 2\times die\ area }} d i e a re a π × ( 2 w a f er d iam e t er ) 2 − 2 × d i e a re a π × w a f er d iam e t er
MOS
二极管基础/半导体器件复习
二极管正偏 → 促进多子漂移,也即在(对方区域的)过剩少子扩散,在P/N两区过剩载流子随着深入不断减小 → 电流从 P 向 N 流过二极管,称为正偏
二极管反偏 → 抑制了(对方区域的)少子扩散,漂移电流为主导(只有自己区域的少子被驱动),P/N 两区本身的少数载流子随着深入不断增加(靠近耗尽区的被驱动走了一定是先驱动走耗尽区的再说别的 ) → 电流从 N 流到 P ,且很小
正偏耗尽层宽度缩小,结电容增加(相当于电容极板间距减小),反偏则完全相反
注意栅极传递和通过源极/漏极掺杂
MOS管
PMOS/NMOS指的是源漏级的性质,以及沟道的性质
源极和漏极在物理上相同,只能通过相对电压来区分
NMOS:低电压为源极,高电压为漏极
PMOS:高电压为源极,高电压为漏极
L是晶体管沟道的长度
NMOS 不能完全上拉,PMOS 不能完全下拉。
静态特性
阈值电压
V T = V T 0 + γ ( ∣ ( − 2 ) ϕ F + V S B ∣ − ∣ − 2 ϕ F ∣ ) V_{T}=V_{T_{0}}+\gamma(\sqrt{ \mid(-2)\phi_{F}+V_{SB}\mid }-\sqrt{ \mid-2 \phi_{F} \mid}) V T = V T 0 + γ ( ∣ ( − 2 ) ϕ F + V SB ∣ − ∣ − 2 ϕ F ∣ ) V T 0 V_{T_{0}} V T 0 V S B = 0 V_{SB}=0 V SB = 0 γ \gamma γ V S B V_{SB} V SB ϕ F = ϕ T ln ( N A n i ) \phi_{F}=\phi_{T} \ln\left( \frac{N_{A}}{n_{i}} \right) ϕ F = ϕ T ln ( n i N A ) ϕ T \phi_{T} ϕ T K T q \frac{KT}{q} q K T γ N M O S = t o x ϵ o x 2 q ϵ S i N A = 2 q ϵ S i N A C o x \gamma_{NMOS} = \frac{t_{ox}}{\epsilon_{ox}} \sqrt{2q\epsilon_{Si}N_A} = \frac{\sqrt{2q\epsilon_{Si}N_A}}{C_{ox}} γ NMOS = ϵ o x t o x 2 q ϵ S i N A = C o x 2 q ϵ S i N A γ P M O S = − t o x ϵ o x 2 q ϵ S i N D = − 2 q ϵ S i N D C o x \gamma_{PMOS} = -\frac{t_{ox}}{\epsilon_{ox}} \sqrt{2q\epsilon_{Si}N_D} = -\frac{\sqrt{2q\epsilon_{Si}N_D}}{C_{ox}} γ PMOS = − ϵ o x t o x 2 q ϵ S i N D = − C o x 2 q ϵ S i N D
DC性质
区域/性质 正常NMOS 短沟道NMOS 长沟道NMOS Cut-off I d s = 0 I_{ds}=0 I d s = 0 对 V G T ≤ 0 V_{GT}\leq 0 V GT ≤ 0 I D = 0 I_{D}=0 I D = 0 Linear V G S > V T V_{GS}>V_{T} V GS > V T V D S < V G S − V T V_{DS}<V_{GS}-V_{T} V D S < V GS − V T I D = μ n C o x W L ( ( V G S − V T ) V D S − V D S 2 2 ) I_{D}=\mu_{n}C_{ox} \frac{W}{L}\left( (V_{GS}-V_{T})V_{DS}-\frac{V_{DS}^2}{2} \right) I D = μ n C o x L W ( ( V GS − V T ) V D S − 2 V D S 2 ) μ n C o x = k n ′ \mu_{n}C_{ox}=k_{n}' μ n C o x = k n ′ 对 V G T ≥ 0 V_{GT}\geq 0 V GT ≥ 0 I D = k ′ W L [ V G T V m i n − V m i n 2 2 ] ( 1 + λ V D S ) I_D = k' \frac{W}{L} \left[ V_{GT}V_{min} - \frac{V_{min}^2}{2} \right] (1 + \lambda V_{DS}) I D = k ′ L W [ V GT V min − 2 V min 2 ] ( 1 + λ V D S ) k ′ k' k ′ V m i n = m i n ( V G T , V D S , V D S A T ) V_{min}=min(V_{GT},V_{DS},V_{DSAT}) V min = min ( V GT , V D S , V D S A T ) Saturation V G S > V T V_{GS}>V_{T} V GS > V T V D S ≥ V G S − V T V_{DS}\geq V_{GS}-V_{T} V D S ≥ V GS − V T I D = μ n C o x W 2 L ( V G S − V T ) 2 I_{D}=\mu_{n}C_{ox} \frac{W}{2L}(V_{GS}-V_{T})^2 I D = μ n C o x 2 L W ( V GS − V T ) 2 根据沟长调制效应,I D = I D ′ ( 1 + λ V D S ) I_{D}=I_{D}'(1+\lambda V_{DS}) I D = I D ′ ( 1 + λ V D S ) I D ′ I_{D}' I D ′
沟长调制效应: V D S V_{DS} V D S
亚阈值 :电流在 V G S = V T V_{GS}=V_{T} V GS = V T
亚阈值电流 exponentially increased with
降低 V T V_{T} V T
增加 V D D V_{DD} V DD
增加 V D S V_{DS} V D S
增加温度
其中上表中的短沟道NMOS那一列,被认为是用于手工分析的通用MOS模型。下面是上面式子涉及的模型参数( 0.25 μ m 0.25\mu m 0.25 μ m
参数 NMOS PMOS V T 0 V_{T0} V T 0 0.43 -0.4 γ \gamma γ 0.5 ^{0.5} 0.5 0.4 -0.4 V D S A T V_{DSAT} V D S A T 0.63 -1 K ′ K' K ′ 2 ^2 2 115 × 1 0 − 6 115\times10^{-6} 115 × 1 0 − 6 − 30 × 1 0 − 6 -30\times10^{-6} − 30 × 1 0 − 6 λ \lambda λ − 1 ^{-1} − 1 0.06 -0.1 通过考虑 MOS 充放电一个电容(一般考虑 V D D 2 \frac{V_{DD}}{2} 2 V DD V D D V_{DD} V DD t p t_{p} t p R e q = 3 4 V D D I S A T ( 1 − 7 9 λ V D D ) R_{eq}=\frac{3}{4} \frac{V_{DD}}{I_{SAT}} \left( 1-\frac{7}{9}\lambda V_{DD} \right) R e q = 4 3 I S A T V DD ( 1 − 9 7 λ V DD ) 假设电源电压远大于晶体管速度饱和电压 V S A T V_{SAT} V S A T I S A T I_{SAT} I S A T V S A T V_{SAT} V S A T 有关电阻的一些结论:
电阻反比于器件的 W L \frac{W}{L} L W
但 V D D ≫ V T + V D S A T 2 V_{DD}\gg V_{T}+\frac{V_{DSAT}}{2} V DD ≫ V T + 2 V D S A T
电源接近 V T V_{T} V T
动态特性
MOS 结构电容(覆盖电容:源和漏在氧化层下延展的横向扩散引起的栅和源漏间的寄生电容,称为覆盖电容)
C G S O = C G D O = C o x x d W C_{GSO}=C_{GDO}=C_{ox}x_{d}W C GSO = C G D O = C o x x d W C o x C_{ox} C o x x d x_{d} x d W W W
沟道电荷(栅至沟道电容 C G C C_{GC} C GC C G C S C_{GCS} C GCS C G C D C_{GCD} C GC D C G C B C_{GCB} C GCB
工作区域 C G C B C_{GCB} C GCB C G C S C_{GCS} C GCS C G C D C_{GCD} C GC D C G C = C G C B + C G C S + C G C D C_{GC}=C_{GCB}+C_{GCS}+C_{GCD} C GC = C GCB + C GCS + C GC D C G = C G C + C o v e r l a p C_{G}=C_{GC}+C_{overlap} C G = C GC + C o v er l a p 器件情况 截止区 C o x W L C_{ox}WL C o x W L 0 0 0 0 0 0 C o x W L C_{ox}WL C o x W L C o x W L + 2 C o W C_{ox}WL+2C_{o}W C o x W L + 2 C o W 截止区域没有任何沟道存在, C G C C_{GC} C GC 电阻区 0 0 0 C o x W L / 2 C_{ox}WL/2 C o x W L /2 C o x W L / 2 C_{ox}WL/2 C o x W L /2 C o x W L C_{ox}WL C o x W L C o x W L + 2 C o W C_{ox}WL+2C_{o}W C o x W L + 2 C o W 形成反型层,作用是源和漏之间的导体,电容在源和漏之间平均分布; C G C B = 0 C_{GCB}=0 C GCB = 0 饱和区 0 0 0 ( 2 / 3 ) C o x W L (2/3)C_{ox}WL ( 2/3 ) C o x W L 0 0 0 ( 2 / 3 ) C o x W L (2/3)C_{ox}WL ( 2/3 ) C o x W L ( 2 / 3 ) C o x W L + 2 C o W (2/3)C_{ox}WL+2C_{o}W ( 2/3 ) C o x W L + 2 C o W 沟道被夹断,栅与漏之间的电容近似为 0 0 0 0 0 0
漏和源反向pn结的耗尽区(反向偏置的源-体和漏-体之间的pn结的耗尽区)的结电容(C S B C_{SB} C SB C D B C_{DB} C D B
示意图:
底板pn结:源区( 掺杂 N D N_{D} N D N A N_{A} N A C b o t t o m = C j W L s = C j × A R E A C_{bottom}=C_{j}WL_{s}=C_{j}\times AREA C b o tt o m = C j W L s = C j × A RE A C j C_{j} C j M j M_{j} M j 0.5 0.5 0.5
其中 C j = C j 0 ( 1 + V s b ϕ 0 ) − M j C_{j}=C_{j_{0}}\left( 1+\frac{V_{sb}}{\phi_{0}} \right)^{-M_{j}} C j = C j 0 ( 1 + ϕ 0 V s b ) − M j C j 0 C_{j_{0}} C j 0 ϕ 0 \phi_{0} ϕ 0 ϕ 0 = k T q ln ( N D N A n i 2 ) \phi_{0}=\frac{kT}{q}\ln\left( \frac{N_{D}N_{A}}{n_{i}^2} \right) ϕ 0 = q k T ln ( n i 2 N D N A )
侧壁pn结:源区(掺杂 N D N_{D} N D p + p^+ p + N A + N_{A}^+ N A + N A N_{A} N A C s w = C s w ′ x j ( W + 2 × L s ) = C j b s s w × P S C_{sw}=C_{sw}'x_{j}(W+2\times L_{s})=C_{jbssw}\times PS C s w = C s w ′ x j ( W + 2 × L s ) = C jb ss w × PS W + 2 × L s W+2\times L_{s} W + 2 × L s x j x_{j} x j C j s w ′ C'_{jsw} C j s w ′ C j b s s w = C j s w ′ x j C_{jbssw}=C_{jsw}'x_{j} C jb ss w = C j s w ′ x j M J S W M_{JSW} M J S W 0.33 ∼ 0.5 0.33\sim 0.5 0.33 ∼ 0.5
其中 C j b s s w = C j s w ( 1 + V s b ϕ 0 ) − M J S W C_{jbssw}=C_{jsw}\left( 1+\frac{V_{sb}}{\phi_{0}} \right)^{-M_{JSW}} C jb ss w = C j s w ( 1 + ϕ 0 V s b ) − M J S W C j s w C_{jsw} C j s w
0.35 微米以下,沿沟道侧也会有电容,会加一项, W C j b s s w g WC_{jbsswg} W C jb ss w g
C j b s s w g = C J S W ( 1 + V s b ϕ 0 ) − M J S W G C_{jbsswg}=C_{JSW}\left( 1+\frac{V_{sb}}{\phi_{0}} \right)^{-M_{JSWG}} C jb ss w g = C J S W ( 1 + ϕ 0 V s b ) − M J S W G
C S B = C S d i f f = C b o t t o m + C s w + C j b s s w g W = C D d i f f = C D B C_{SB}=C_{Sdiff}=C_{bottom}+C_{sw}+C_{jbsswg}W=C_{Ddiff}=C_{DB} C SB = C S d i ff = C b o tt o m + C s w + C jb ss w g W = C D d i ff = C D B
器件电容模型
C G S = C G C S + C G S O C_{GS}=C_{GCS}+C_{GSO} C GS = C GCS + C GSO C G D = C G C D + C G D O C_{GD}=C_{GCD}+C_{GDO} C G D = C GC D + C G D O C G B = C G C B C_{GB}=C_{GCB} C GB = C GCB C S B = C S d i f f C_{SB}=C_{Sdiff} C SB = C S d i ff C D B = C D d i f f C_{DB}=C_{Ddiff} C D B = C D d i ff 示意图
一些非理想效应
沟道长度调制效应(见前)
体效应(见前)
短沟道效应:沟道长度减小,源极和漏极端口周围的耗尽区会很接近,相比长沟道,短沟道 MOSFET 中栅极对沟道的控制较弱,随着沟道长�度缩小,MOSFET的阈值电压降低,同时改变的还有载流子的Mobility,以及沟道电流
DIBL:随着源漏极/体端pn结的反向偏置电压增加,耗尽层的深度对沟道的耗尽电荷贡献增大,增加漏极到体的反向偏压会增强短沟道效应,并降低阈值电压。
热载流子效应:器件尺寸持续缩小,但电源和工作电压未进行缩放,电子的热效应上升
亚阈值区(见前)
闩锁效应:电源 VDD 和地线 GND 之间寄生的 PNP 和 NPN 双极性影响产生的低阻抗通路
不同工艺之间的差异:晶体管的参数(有效沟道长度,阈值电压,栅氧厚度)围绕典型值 T T T
对于快速的晶体管( F F F T T T L e f f L_{eff} L e ff V T V_{T} V T t o x t_{ox} t o x V D D V_{DD} V DD T T T
温度升高:迁移率降低, V T V_{T} V T
有很多非理想效应会导致亚阈值区的电流泄露
亚阈值导电
结漏(反向偏置的PN结中存在二极管电流)
栅漏(穿过超薄栅介质的隧穿)
DIBL
GIDL(栅漏电流击穿)
穿通
窄沟道效应
热载流子注入
Invertor
理想 CMOS 反相器的特性
V O H = V D D V_{OH}=V_{DD} V O H = V DD V O L = G N D V_{OL}=GND V O L = GN D 逻辑电平与器件的尺寸无关(无比逻辑)
稳态时 V D D V_{DD} V DD G N D GND GN D 低输出阻抗
MOS 管栅视为绝缘体,高输入阻抗
电源线/地线之间没有直接的通路,不消耗任何静态功率
静态特性
VTC:通过转换 PMOS 特性,找到交点,之后得到VTC曲线
VTC曲线以及其中晶体管的工作模式
开关阈值计算: V M V_{M} V M V i n = V o u t V_{in}=V_{out} V in = V o u t 速度饱和态 (电源电压足够高)。令通过两管的电流相等,且忽略沟长调制效应,因此有:
V M = ( V T n + V D S A T n 2 ) + r ( V D D + V T p + V D S A T p 2 ) 1 + r V_M = \frac{\left(V_{Tn} + \frac{V_{DSATn}}{2}\right) + r\left(V_{DD} + V_{Tp} + \frac{V_{DSATp}}{2}\right)}{1 + r} V M = 1 + r ( V T n + 2 V D S A T n ) + r ( V DD + V Tp + 2 V D S A Tp ) V D D V_{DD} V DD V M ≈ r V D D 1 + r V_M \approx \frac{rV_{DD}}{1 + r} V M ≈ 1 + r r V DD r = k p V d s a t p k n V d s a t n = k p ′ V d s a t p β p k n ′ V d s a t n β n r = \frac{k_p V_{dsatp}}{k_n V_{dsatn}} = \frac{k_p' V_{dsatp} \beta_p}{k_n' V_{dsatn} \beta_n} r = k n V d s a t n k p V d s a tp = k n ′ V d s a t n β n k p ′ V d s a tp β p β p β n = W p / L p W n / L n = k n ′ V d s a t n ( V M − V T n − V d s a t n 2 ) k p ′ V d s a t p ( V D D − V M + V T p + V d s a t p 2 ) \frac{\beta_p}{\beta_n} = \frac{W_p/L_p}{W_n/L_n} = \frac{k'_n V_{dsatn} \left(V_M - V_{Tn} - \frac{V_{dsatn}}{2}\right)}{k'_p V_{dsatp} \left(V_{DD} - V_M + V_{Tp} + \frac{V_{dsatp}}{2}\right)} β n β p = W n / L n W p / L p = k p ′ V d s a tp ( V DD − V M + V Tp + 2 V d s a tp ) k n ′ V d s a t n ( V M − V T n − 2 V d s a t n ) r r r
V M V_{M} V M
它对于器件比值的变化相对来说不敏感
改变器件的参数的影响是让 V T C VTC V TC
有关尺寸比 :尺寸比越大, V M V_{M} V M V M V_{M} V M
在开关阈值处的增益:g = 1 + r ( V M − V T n − V D S A T n / 2 ) ( λ n − λ p ) g=\frac{1 + r}{(V_M - V_{Tn} - V_{DSATn}/2)(\lambda_n - \lambda_p)} g = ( V M − V T n − V D S A T n /2 ) ( λ n − λ p ) 1 + r 这里没有忽略沟长�调制效应 ),选择电源电压/晶体管尺寸只能造成很小的影响。
求解增益的目的是找噪声容限。将VTC进行简化如下:
这样,就可以将其视作一个线性的函数进行求解。于是有:V I H = V M − V M g V_{IH} = V_M - \frac{V_M}{g} V I H = V M − g V M V I L = V M + V D D − V M g V_{IL} = V_M + \frac{V_{DD} - V_M}{g} V I L = V M + g V DD − V M N M H = V D D − V I H NM_H = V_{DD} - V_{IH} N M H = V DD − V I H N M L = V I L NM_L = V_{IL} N M L = V I L
电源电压降低一定的程度,可以提高 g g g V D D m i n > 2 … 4 k T q V_{DDmin}>2\dots4 \frac{kT}{q} V DD min > 2 … 4 q k T
动态特性
要求反相器的动态特性,也就是反相器在输入信号变化后,输出特性发生怎样的变化,就要知道反相器的延迟时间。而我们可以把反相器等效成如下的电路,并通过计算电容和电阻得到延迟时间。
电容:考虑一对串联反相器动态特性的寄生电容
图:
由于 M 1 M_{1} M 1 M 2 M_{2} M 2 C g d 12 = 2 C G D 0 W C_{gd12}=2C_{GD0}W C g d 12 = 2 C G D 0 W 2 C g d 12 2C_{gd12} 2 C g d 12
对于扩散电容 C d b 1 C_{db_{1}} C d b 1 C d b 2 C_{db_{2}} C d b 2 C e q = K e q C j 0 C_{eq}=K_{eq}C_{j_{0}} C e q = K e q C j 0 C e q = − ϕ 0 m ( 1 − m ) ( V h i g h − V l o w ) [ ( ϕ 0 − V h i g h ) 1 − m − ( ϕ 0 − V l o w ) 1 − m ] C j 0 = K e q C j 0 \mathcal{C}_{eq} = -\frac{{\phi_0}^m}{(1-m)(V_{high}-V_{low})}[(\phi_0-V_{high})^{1-m}-(\phi_0-V_{low})^{1-m}]C_{j0} = K_{eq}C_{j0} C e q = − ( 1 − m ) ( V hi g h − V l o w ) ϕ 0 m [( ϕ 0 − V hi g h ) 1 − m − ( ϕ 0 − V l o w ) 1 − m ] C j 0 = K e q C j 0 ϕ 0 \phi_{0} ϕ 0 m m m V h i g h V_{high} V hi g h V l o w V_{low} V l o w 50 % 50\% 50% 0 0 0 V D D V_{DD} V DD
假设输出高电平为 V o u t V_{out} V o u t
输出由高到低:NMOS: V h i g h = − 2.5 V V_{high}=-2.5V V hi g h = − 2.5 V V l o w = − 1.25 V V_{low}=-1.25V V l o w = − 1.25 V V h i g h = − 1.25 V V_{high}=-1.25V V hi g h = − 1.25 V V l o w = 0 V_{low}=0 V l o w = 0
输出由低到高:NMOS: V l o w = 0 V_{low}=0 V l o w = 0 V h i g h = − 1.25 V V_{high}=-1.25V V hi g h = − 1.25 V V l o w = − 1.25 V V_{low}=-1.25V V l o w = − 1.25 V V h i g h = − 2.5 V V_{high}=-2.5V V hi g h = − 2.5 V
特别需要注意的是:计算完之后还要乘以面积/周长的!!!
扇出的栅电容:C f a n o u t = ( C G S O N + C G D O N + W n L n C o x ) + ( C G S O P + C G D O P + W p L p C o x ) C_{fanout}=(C_{GSON} + C_{GDON} + W_nL_nC_{ox}) + (C_{GSOP} + C_{GDOP} + W_pL_pC_{ox}) C f an o u t = ( C GSON + C G D ON + W n L n C o x ) + ( C GSOP + C G D OP + W p L p C o x )
假设栅电容所有部分都在 V o u t V_{out} V o u t G N D GND GN D V D D V_{DD} V DD
近似认为门沟道电容保持不变,并近似为 W n L n C o x W_nL_nC_{ox} W n L n C o x
连线电容:直接代入即可
有关电容的表格总结:
电容 公式 C g d 1 C_{gd1} C g d 1 2 C G D O p ⋅ W n 1 2C_{GDOp} \cdot W_{n1} 2 C G D Op ⋅ W n 1 C g d 2 C_{gd2} C g d 2 2 C G D O p ⋅ W p 2 2C_{GDOp} \cdot W_{p2} 2 C G D Op ⋅ W p 2 C d b 1 C_{db1} C d b 1 A D n 1 K e q n C j + P D n 1 K e q s w n C J S W AD_{n1}K_{eqn}C_j + PD_{n1}K_{eqswn}C_{JSW} A D n 1 K e q n C j + P D n 1 K e q s w n C J S W C d b 2 C_{db2} C d b 2 A D p 2 K e q p C j + P D p 2 K e q s w p C J S W AD_{p2}K_{eqp}C_j + PD_{p2}K_{eqswp}C_{JSW} A D p 2 K e qp C j + P D p 2 K e q s wp C J S W C g 3 C_{g3} C g 3 ( C G D O n + C G S O n ) W n 3 + C o x W n 3 L n 3 (C_{GDOn} + C_{GSO_n})W_{n3} + CoxW_{n3}L_{n3} ( C G D O n + C GS O n ) W n 3 + C o x W n 3 L n 3 C g 4 C_{g4} C g 4 ( C G D O p + C G S O p ) W p 4 + C o x W p 4 L p 4 (C_{GDOp} + C_{GSO_p})W_{p4} + CoxW_{p4}L_{p4} ( C G D Op + C GS O p ) W p 4 + C o x W p 4 L p 4 C w C_{w} C w C L C_{L} C L ∑ \sum ∑
电阻:R e q = 3 4 V D D I S A T ( 1 − 7 9 λ V D D ) R_{eq}=\frac{3}{4} \frac{V_{DD}}{I_{SAT}} \left( 1-\frac{7}{9}\lambda V_{DD} \right) R e q = 4 3 I S A T V DD ( 1 − 9 7 λ V DD )
传播延迟:
需要注意的是传播延迟是到 50 % 50\% 50% t p H L t_{pHL} t p H L t p L H t_{pLH} t p L H ln 2 C L R e q \ln2C_{L}R_{eq} ln 2 C L R e q t p H L t_{pHL} t p H L t p L H t_{pLH} t p L H C L C_{L} C L
t p = t p H L + t p L H 2 t_{p}=\frac{{t_{pHL}+t_{pLH}}}{2} t p = 2 t p H L + t p L H 然而用上面那个公式还是太复杂了!在面对传播延迟的时候我们不得不进行一波简化。考虑如下的图:
其中 C L = [ ( W n 1 + W n 2 ) C n 0 + ( W p 1 + W p 2 ) C p 0 + C w ] C_L = [(W_{n1} + W_{n2})C_{n0} + (W_{p1} + W_{p2})C_{p0} + C_w] C L = [( W n 1 + W n 2 ) C n 0 + ( W p 1 + W p 2 ) C p 0 + C w ]
然后一通算,并且把 β 1 = W p 1 W n 1 \beta_{1}=\frac{W_{p_{1}}}{W_{n_{1}}} β 1 = W n 1 W p 1
t p H L = ln 2 L n 1 R n 0 [ ( 1 + W n 2 W n 1 ) C n 0 + ( β 1 + W p 2 W n 1 ) C p 0 + C w W n 1 ] t_{pHL}=\ln 2 L_{n1} R_{n0} [(1 + \frac{W_{n2}}{W_{n1}})C_{n0} + (\beta_1 + \frac{W_{p2}}{W_{n1}})C_{p0} + \frac{C_w}{W_{n1}}] t p H L = ln 2 L n 1 R n 0 [( 1 + W n 1 W n 2 ) C n 0 + ( β 1 + W n 1 W p 2 ) C p 0 + W n 1 C w ] t p H L = ln 2 L n 1 W n 1 R n 0 [ ( W n 1 + W n 2 ) C n 0 + ( W p 1 + W p 2 ) C p 0 + C w ] t_{pHL}=\ln 2 \frac{L_{n1}}{W_{n1}} R_{n0} \left[ (W_{n1} + W_{n2})C_{n0} + (W_{p1} + W_{p2})C_{p0} + C_w \right] t p H L = ln 2 W n 1 L n 1 R n 0 [ ( W n 1 + W n 2 ) C n 0 + ( W p 1 + W p 2 ) C p 0 + C w ] t p L H = ln 2 L p 1 R p 0 [ ( 1 β 1 + W n 2 W p 1 ) C n 0 + ( 1 + W p 2 W p 1 ) C p 0 + C w W p 1 ] t_{pLH}=\ln 2 L_{p1} R_{p0} \left[ \left( \frac{1}{\beta_1} + \frac{W_{n2}}{W_{p1}} \right) C_{n0} + \left( 1 + \frac{W_{p2}}{W_{p1}} \right) C_{p0} + \frac{C_w}{W_{p1}} \right] t p L H = ln 2 L p 1 R p 0 [ ( β 1 1 + W p 1 W n 2 ) C n 0 + ( 1 + W p 1 W p 2 ) C p 0 + W p 1 C w ] t p L H = ln 2 L n 1 W n 1 R n 0 [ ( W n 1 + W n 2 ) C n 0 + ( W p 1 + W p 2 ) C p 0 + C w ] t_{pLH}=\ln 2 \frac{L_{n1}}{W_{n1}} R_{n0} \left[ (W_{n1} + W_{n2})C_{n0} + (W_{p1} + W_{p2})C_{p0} + C_w \right] t p L H = ln 2 W n 1 L n 1 R n 0 [ ( W n 1 + W n 2 ) C n 0 + ( W p 1 + W p 2 ) C p 0 + C w ]
这之后我们想知道如何设计器件以达到下面两种情况:
t p H L = t p L H t_{pHL}=t_{pLH} t p H L = t p L H R p 0 R n 0 = β \frac{R_{p_{0}}}{R_{n_{0}}}=\beta R n 0 R p 0 = β β \beta β β \beta β r r r t p t_{p} t p β = r \beta=\sqrt{ r } β = r 图示
反相器链
上一节中的电容式子还是太复杂了,所以我们认为 C L = C i n t + C e x t C_{L}=C_{int}+C_{ext} C L = C in t + C e x t C i n t C_{int} C in t C e x t C_{ext} C e x t t p t_{p} t p t p = 0.69 R e q C i n t ( 1 + C e x t C i n t ) = t p 0 ( 1 + C e x t C i n t ) t_{p}=0.69R_{eq}C_{int}\left( 1+\frac{C_{ext}}{C_{int}} \right)=t_{p_{0}}\left( 1+\frac{C_{ext}}{C_{int}} \right) t p = 0.69 R e q C in t ( 1 + C in t C e x t ) = t p 0 ( 1 + C in t C e x t ) C i r e f C_{iref} C i re f R r e f R_{ref} R re f C i n t = S C i r e f C_{int}=SC_{iref} C in t = S C i re f R e q = R r e f S R_{eq}=\frac{R_{ref}}{S} R e q = S R re f t p = t p 0 ( 1 + C e x t S C i r e f ) t_{p}=t_{p_{0}}\left( 1+\frac{C_{ext}}{SC_{iref}} \right) t p = t p 0 ( 1 + S C i re f C e x t ) S S S
实际情况中,反相器门是在反相器链中的。因此建立输入栅电容(在反相器链中,前一个电容的外部负载电容基本可以等效为后一个电容的栅电容)和本征输入电容的关系: C i n t = γ C g C_{int}=\gamma C_{g} C in t = γ C g t p = t p 0 ( 1 + C e x t γ C g ) = t p 0 ( 1 + f γ ) t_p = t_{p0}\left(1 + \frac{C_{ext}}{\gamma C_g}\right) = t_{p0}(1 + \frac{f}{\gamma}) t p = t p 0 ( 1 + γ C g C e x t ) = t p 0 ( 1 + γ f �� ) f f f
假设有一个反相器链,也就可以列出一堆这样的式子,再求最小值。可以得到每一个反相器的最优尺寸(当总延迟时间最短时 ):C g , j = C g , j − 1 ⋅ C g , j + 1 C_{g,j} = \sqrt{C_{g,j-1} \cdot C_{g,j+1}} C g , j = C g , j − 1 ⋅ C g , j + 1 f f f f = C L C g , 1 N = F N f = \sqrt[N]{\frac{C_L}{C_{g,1}}} = \sqrt[N]{F} f = N C g , 1 C L = N F N = ln F ln f N=\frac{{\ln F}}{\ln f} N = l n f l n F F F F t p = N t p 0 ( 1 + F N / γ ) t_p = N t_{p0}(1 + \sqrt[N]{F}/\gamma) t p = N t p 0 ( 1 + N F / γ )
对于 γ = 1 \gamma=1 γ = 1 f o p t = 3.6 ( 4 ) f_{opt}=3.6(4) f o pt = 3.6 ( 4 )
解答类似问题的时候,需要注意下图中这样的也要算进电容里。
需要注意的是,反相器的输入信号不是立即跳变,而是有一定的上升和下降时间。而这正是前一级门的有限驱动能力造成的。考虑这点,可以得到反相器链中反相器 i i i t p i = t s t e p i + η t s t e p i − 1 t_p^i = t_{step}^i + \eta t_{step}^{i-1} t p i = t s t e p i + η t s t e p i − 1 t s t e p t_{step} t s t e p 0 0 0 t p 1 = t s 1 t_{p_{1}}=t_{s_{1}} t p 1 = t s 1
当 t s > t p t_{s}>t_{p} t s > t p t p t_{p} t p t s t_{s} t s
t s t_{s} t s
能量与功耗
注意:CMOS管invert在静态(无负载)和动态(有负载)的状态是不同的,后者因为有Load,实际的结果应该是如下图的
CMOS 在静态工作时几乎没有功耗
动态功耗
由充放电电容引起的功耗: P d y n = C L V D D 2 f 0 → 1 = C L V D D 2 P 0 → 1 f = C E F F V D D 2 f P_{dyn}=C_{L}V_{DD}^2f_{0\to1}=C_L V_{DD}^2 P_{0 \rightarrow 1} f = C_{EFF} V_{DD}^2 f P d y n = C L V DD 2 f 0 → 1 = C L V DD 2 P 0 → 1 f = C EFF V DD 2 f f 0 → 1 f_{0\to1} f 0 → 1 0 → 1 0\to1 0 → 1 P 0 → 1 P_{0\to 1} P 0 → 1 f f f C E F F = P 0 → 1 C L C_{EFF}=P_{0\to1}C_{L} C EFF = P 0 → 1 C L
反相器翻转的最大可能的速率: T = 1 f = t p L H + t p H L = 2 t p T=\frac{1}{f}=t_{pLH}+t_{pHL}=2t_{p} T = f 1 = t p L H + t p H L = 2 t p
翻转因子计算:对于输入统计学上互相独立的CMOS门 P 0 → 1 P_{0\to 1} P 0 → 1 0 0 0 1 1 1
直接通路电流引起的功耗:波形的上升/下降时间并不为零,这导致在波形上升/下降时 V D D V_{DD} V DD G N D GND GN D E d p = t s c V D D I p e a k E_{dp}=t_{sc}V_{DD}I_{peak} E d p = t sc V DD I p e ak P d p = t s c V D D I p e a k f = C s c V D D 2 f P_{dp}=t_{sc}V_{DD}I_{peak}f=C_{sc}V_{DD}^2f P d p = t sc V DD I p e ak f = C sc V DD 2 f t s c t_{sc} t sc
t s c = V D D − 2 V T V D D t s ≈ V D D − 2 V T V D D × t r ( f ) 0.8 t_{sc} = \frac{V_{DD} - 2V_T}{V_{DD}} t_s \approx \frac{V_{DD} - 2V_T}{V_{DD}} \times \frac{t_{r(f)}}{0.8} t sc = V DD V DD − 2 V T t s ≈ V DD V DD − 2 V T × 0.8 t r ( f ) t r ( f ) t_{r(f)} t r ( f ) t r i s e t_{rise} t r i se t f a l l t_{fall} t f a ll 计算 I p e a k I_{peak} I p e ak
I p e a k I_{peak} I p e ak C L C_{L} C L C L C_{L} C L 具体计算:把 I p e a k I_{peak} I p e ak I p e a k I_{peak} I p e ak t s c t_{sc} t sc
短路电流功耗可以通过让输入输出信号上升/下降时间相等来最小化
降低电源电压
静态功耗
静态功耗 P s t a t = I s t a t V D D P_{stat}=I_{stat}V_{DD} P s t a t = I s t a t V DD
I s t a t I_{stat} I s t a t 泄露电流的来源:晶体管的亚阈值电流,Gate leakage,Drain junction leakage(leakage一定是电源到地的)
堆叠晶体管可以降低leakage
总功耗:
P t o t = P d y n + P d p + P s t a t = ( C L V D D 2 + V D D I p e a k t s ) f 0 → 1 + V D D I l e a k P_{tot} = P_{dyn} + P_{dp} + P_{stat} = (C_L V_{DD}^2 + V_{DD} I_{peak} t_s) f_{0 \rightarrow 1} + V_{DD} I_{leak} P t o t = P d y n + P d p + P s t a t = ( C L V DD 2 + V DD I p e ak t s ) f 0 → 1 + V DD I l e ak
一个逻辑门的质量评定指标
功耗延迟积:P D P = P a v t P PDP=P_{av}t_{P} P D P = P a v t P
能量延迟积: E D P = P D P × t p EDP=PDP\times t_{p} E D P = P D P × t p
确定晶体管尺寸使能耗最小
通过性能约束(电路传播延时小于等于参考电路( f = 1 f=1 f = 1 f f f E E r e f = ( V D D V r e f ) 2 ( 2 + 2 f + F 4 + F ) \frac{E}{E_{ref}} = \left(\frac{V_{DD}}{V_{ref}}\right)^2 \left(\frac{2 + 2f + F}{4 + F}\right) E re f E = ( V re f V DD ) 2 ( 4 + F 2 + 2 f + F ) γ = 1 \gamma=1 γ = 1
画图可以找到 m i n min min
工艺尺寸缩小对反相器衡量指标的影响
缩小的技术
全比例缩小:比例和电压缩小 S S S
恒压缩小:只改变比例,电压不变
一般化缩小:比例和电压按不同比例缩小
S S S U U U
Parameter Relation Full Scaling General Scaling Fixed-Voltage Scaling W , L , t o x W, L, t_{ox} W , L , t o x - 1/S 1/S 1/S V D D , V T V_{DD}, V_T V DD , V T - 1/S 1/U 1 N S U B N_{SUB} N S U B V / W d e p l 2 V/W_{depl}^2 V / W d e pl 2 S S 2 / U S^2/U S 2 / U S 2 S^2 S 2 Area/Device W L WL W L 1/S 2 S^2 S 2 1/S 2 S^2 S 2 1/S 2 S^2 S 2 C α C_{\alpha} C α 1/t o x t_{ox} t o x S S S C g a t e C_{gate} C g a t e C o x W L C_{ox}WL C o x W L 1/S 1/S 1/S k n k p k_n k_p k n k p C o x W / L C_{ox}W/L C o x W / L S S S I s a t I_{sat} I s a t C o x W V C_{ox}WV C o x WV 1/S 1/U 1 Current Density I s a t / A r e a I_{sat}/Area I s a t / A re a S S 2 / U S^2/U S 2 / U S 2 S^2 S 2 R o n R_{on} R o n V / I s a t V/I_{sat} V / I s a t 1 1 1 Intrinsic Delay R o n C g a t e R_{on}C_{gate} R o n C g a t e 1/S 1/S 1/S P P P I s a t V I_{sat}V I s a t V 1/S 2 S^2 S 2 1/U 2 U^2 U 2 1 Power Density P / A r e a P/Area P / A re a 1 S 2 / U 2 S^2/U^2 S 2 / U 2 S 2 S^2 S 2
集成电路的导线模型
导线模型的简化
忽略电感:电阻很大(截面很小的长铝导线),外加信号的上升/下降时间很慢
只含电容:导线短。导线截面大,使用互连材料电阻率很低
忽略导线相互间的电容:相邻导线的间距很大,且导线只在很短的距离上靠近在一起的时候
互连线设计的规则/趋势
更好的互连材料(铜或者硅化物,带来更好的导电性)/低介电常数材料(更低的电容)
先进的互联拓扑结构/更多的互连层;互连层较低层为薄密层,较高层为厚宽层。
平行板电容模型: C i n t = ϵ d i t d i W L C_{int}=\frac{\epsilon_{di}}{t_{di}}WL C in t = t d i ϵ d i W L ϵ d i = ϵ r ϵ 0 \epsilon_{di}=\epsilon_{r}\epsilon_{0} ϵ d i = ϵ r ϵ 0
由于我们想要在减小工艺尺寸的同时让导线的电阻最小,因此要保证截面 W × H W\times H W × H W W W W H \frac{W}{H} H W C f r i n g e C_{fringe} C f r in g e C w i r e = C p p + C f r i n g e r = w ϵ d i t d i + 2 π ϵ s i log ( 2 t d i / H + 1 ) C_{wire} = C_{pp} + C_{fringer} = \frac{w \epsilon_{di}}{t_{di}} + \frac{2 \pi \epsilon_{si}}{\log(2t_{di}/H + 1)} C w i re = C pp + C f r in g er = t d i w ϵ d i + l o g ( 2 t d i / H + 1 ) 2 π ϵ s i w = W − H 2 w=W-\frac{H}{2} w = W − 2 H
现代半导体工艺提供了更多的互连层,因此要考虑更多的电容C t o t a l = C i n t e r n a l − l a y e r − i n t e r w i r e + C i n n e r − l a y e r − i n t e r w i r e + C g r o u n d C_{total}=C_{internal-layer-interwire}+C_{inner-layer-interwire}+C_{ground} C t o t a l = C in t er na l − l a yer − in t er w i re + C inn er − l a yer − in t er w i re + C g ro u n d 随着器件缩小,主要的电容是interwire电容
一般来说这些电容难以计算,一般计算题会给出图表。如何看图:
矩形导体的电阻 R = ρ L A R=\frac{\rho L}{A} R = A ρ L A = H W A=HW A = H W H H H R = R □ L W R = R_{\square} \frac{L}{W} R = R □ W L R □ = ρ H R_{\square}=\frac{\rho}{H} R □ = H ρ
布线层之间的转接带来额外电阻(接触电阻),比较好的测量是使信号线保持在同一层上避免过多的接触或通孔。接触孔较大可以降低接触电阻,但电流常常集中在较大接触孔的周边。
在较高的频率下,半导体导线会出现趋肤效应。高频电流倾向于主要在导体的表面流动,电流密度随进入导体的深度而指数 下降。这也影响了导线电阻。
δ \delta δ e − 1 e^{-1} e − 1 δ = ρ π f μ \delta=\sqrt{ \frac{\rho}{\pi f\mu} } δ = π f μ ρ 近似为电流均匀流过导体的厚度为 δ \delta δ r ( f ) = π f μ ρ 2 ( H + W ) r(f)=\frac{\sqrt{ \pi f\mu\rho }}{2(H+W)} r ( f ) = 2 ( H + W ) π f μ ρ
电阻增加率: Resistance increase rate = r ( f ) − r r = 1 2 π f μ ρ H H / W + 1 − 1 \text{Resistance increase rate} = \frac{r(f) - r}{r} = \frac{1}{2} \sqrt{\frac{\pi f \mu}{\rho}} \frac{H}{H/W + 1} - 1 Resistance increase rate = r r ( f ) − r = 2 1 ρ π f μ H / W + 1 H − 1
降低频率 f f f
减小导体的宽度 W W W
增大电阻率 ρ \rho ρ
高频时电阻增加 → 导线上传送的信号有额外的衰减,产生失真。趋肤深度等于导体最大尺寸( W W W H H H f s = 4 ρ π μ ( max ( W , H ) ) 2 f_s = \frac{4\rho}{\pi \mu (\max(W, H))^2} f s = π μ ( m a x ( W , H ) ) 2 4 ρ
趋肤效应是较宽导线才有的问题,常常影响时钟信号这类。
串扰(电容寄生效应)
串扰是互连线中电容的寄生效应产生的。由相邻的信号线和电路节点之间不希望的耦合引起的干扰通常叫串扰
根据受串扰的线的性质的不同,可以分为两种情况
Floating line
图示
当Aggressor的电压发生变化时,节点Victim的电压也受到串扰发生变化。
Δ V v i c t i m = C a d j C g n d − v + C a d j Δ V a g g r e s s o r \Delta V_{victim} = \frac{C_{adj}}{C_{gnd-v} + C_{adj}} \Delta V_{aggressor} Δ V v i c t im = C g n d − v + C a d j C a d j Δ V a gg ressor
Driving line
图示
注意Victim此时并非浮空 ,而是被有源驱动。
Δ V v i c t i m = C a d j C g n d − v + C a d j 1 1 + κ Δ V a g g r e s s o r \Delta V_{victim} = \frac{C_{adj}}{C_{gnd-v} + C_{adj}} \frac{1}{1 + \kappa} \Delta V_{aggressor} Δ V v i c t im = C g n d − v + C a d j C a d j 1 + κ 1 Δ V a gg ressor κ = τ a g g r e s s o r τ v i c t i m = R a g g r e s s o r ( C g n d − a + C a d j ) R v i c t i m ( ( C g n d − v + C a d j ) \kappa = \frac{\tau_{aggressor}}{\tau_{victim}} = \frac{R_{aggressor}(C_{gnd-a} + C_{adj})}{R_{victim}((C_{gnd-v} + C_{adj})} κ = τ v i c t im τ a gg ressor = R v i c t im (( C g n d − v + C a d j ) R a gg ressor ( C g n d − a + C a d j )
二者的对比:如果受扰方浮空,则噪声一直持续;若受扰方被驱动,则受扰方在一段事件后复原。
串扰的影响
串扰与性能
图示
三根导线同时翻转, Y Y Y X X X Z Z Z Y Y Y Y Y Y
于是逻辑门 Y Y Y C G N D ≤ C L ≤ C G N D + 4 C c C_{GND}\leq C_{L}\leq C_{GND}+4C_{c} C GN D ≤ C L ≤ C GN D + 4 C c
克服电容串扰的方法(控制电路的几何形态,或者采用对耦合能量不敏感的信号传输规范
尽量避免浮空节点;事先知道对串扰问题敏感的节点(如预充电总线),可以增加保持器件
敏感节点与全摆幅信号隔离
满足时序约束的范围内增加上升/下降时间
导线排布方式
降低两条信号线之间的电容(让同一层上的平行导线尽量足够远离,和邻层的导线互相垂直)
在两个信号之间增加屏蔽线(让线间电容转变为接地电容,消除干扰,但增加了电容负载)
在长导线上使用Regenerators
当电线初始为“0”时,再生器感测到上升沿并加速它。相反,当电线初始为“1”时,再生器会加速下降沿。
导线模型
理想导线模型
没有附加参数或寄生效应,对电路的电气行为没有影响
导线一端的电压变化会立即传播到另一端
导线的每一段在任何时刻都有相同的电压,导线是一个等势区域
集总模型:把不同的寄生元件集总成单个电路元件
前提:只有一个寄生元件占支配地位,且元件之间相互作用很小/只考虑电路特性的一个方面
集总模型(Lump-C Model)
前提:导线的电阻部分很小。且开关频率低/中
分布电容集总为单个电容
方程:C l u m p e d d V o u t d t + V o u t − V i n R d r i v e r = 0 C_{lumped} \frac{dV_{out}}{dt}+ \frac{{V_{out}-V_{in}}}{R_{driver}}=0 C l u m p e d d t d V o u t + R d r i v er V o u t − V in = 0
若 V i n V_{in} V in
V o u t = ( 1 + e − t / τ ) V_{out}=(1+e^{ -t/\tau }) V o u t = ( 1 + e − t / τ ) τ = R d r i v e r C l u m p e d \tau=R_{driver}C_{lumped} τ = R d r i v er C l u m p e d
集总RC模型
长度超过几毫米的片上有较明显的电阻,这时也需要等效电阻。
图示
C l u m p e d d V o u t d t + V o u t − V i n R d r i v e r + R w i r e = 0 C_{lumped} \frac{dV_{out}}{dt}+ \frac{{V_{out}-V_{in}}}{R_{driver}+R_{wire}}=0 C l u m p e d d t d V o u t + R d r i v er + R w i re V o u t − V in = 0 τ = ( R d r i v e r + R w i r e ) C l u m p e d \tau=(R_{driver}+R_{wire})C_{lumped} τ = ( R d r i v er + R w i re ) C l u m p e d
电阻-电容网络与 Elmore 延时公式
大多数电路可以表示成一个RC树
电路仅有一个输入节点 s s s
所有电容都在某节点和地之间
电路不包含电阻回路
特性:源节点 s s s i i i R i i R_{ii} R ii
共享路径 R i k R_{ik} R ik s s s k k k i i i
R i 4 = R 1 + R 3 R_{i4}=R_{1}+R_{3} R i 4 = R 1 + R 3
Elmore 延迟模型的两种描述:从信号源 s s s i i i
τ D i = ∑ k = 1 N R i k C k \tau_{Di}=\sum_{k=1}^NR_{ik}C_{k} τ D i = ∑ k = 1 N R ik C k τ D i = ∑ R k a l o n g p a t h s → i N o . o f R a l o n g p a t h s → i R k ( s u m o f C x d r i v e n b y R k ) \tau_{Di}=\sum_{R_{k}\ along\ path\ s\to i}^{No.of\ R\ along\ path\ s\to i}R_{k}(sum\ of\ C_{x}\ driven\ by\ R_{k}) τ D i = ∑ R k a l o n g p a t h s → i N o . o f R a l o n g p a t h s → i R k ( s u m o f C x d r i v e n b y R k )
分布RC模型
集总RC模型对于长互连线是保守而不精确的模型
图解
每一节点的电压由微分方程确定
计算出来的值很复杂,这里写不下
最好的方法还是用集总模型对其进行近似
用RC Chain对上述过程进行近似:τ D N = r Δ L c Δ L + 2 r Δ L c Δ L + ⋯ + N r Δ L c Δ L = N ( N + 1 ) r c 2 Δ L 2 = N ( N + 1 ) r c L 2 2 R C N 2 ≈ R C 2 = R C L 2 2 \tau_{DN} = r\Delta Lc\Delta L + 2r\Delta Lc\Delta L + \cdots + Nr\Delta Lc\Delta L = \frac{N(N + 1)rc}{2}\Delta L^2 = \frac{N(N + 1)rcL^2}{2} \frac{RC}{N^2} \approx \frac{RC}{2}=\frac{RCL^2}{2} τ D N = r Δ L c Δ L + 2 r Δ L c Δ L + ⋯ + N r Δ L c Δ L = 2 N ( N + 1 ) rc Δ L 2 = 2 N ( N + 1 ) rc L 2 N 2 RC ≈ 2 RC = 2 RC L 2
导线的延时是长度的二次函数
注意分布rc线的延时是按集总模型预测的延时的一半(因为分布式是沿电路分布而不是全部集中在末端)
集总模型代表了电阻导向延时的保守估计
��分布式/集总/用RC Chain近似分布式的对比:
Voltage range Lumped Distributed Elmore Model 0 → 50% (t p t_{p} t p 0.69 R C 0.69RC 0.69 RC 0.38 R C 0.38RC 0.38 RC 0.345 R C \mathbf{0.345RC} 0.345RC 0 → 63% (τ \tau τ R C RC RC 0.5 R C 0.5RC 0.5 RC 0.5 R C \mathbf{0.5RC} 0.5RC 10% → 90% (t r t_{r} t r 2.2 R C 2.2RC 2.2 RC 0.9 R C 0.9RC 0.9 RC 1.1 R C 1.1RC 1.1 RC 0% → 90% 2.3 R C 2.3RC 2.3 RC 1.0 R C 1.0RC 1.0 RC 1.15 R C \mathbf{1.15RC} 1.15RC
经验规则
导线延时在近似/超过驱动门的 t p g a t e t_{pgate} t p g a t e
临界值 L c r t i = t p g a t e 0.38 r c L_{crti}=\sqrt{ \frac{t_{pgate}}{0.38rc} } L cr t i = 0.38 rc t p g a t e
导线延时在导线输入信号的上升下降时间小于导线的上升下降时间才考虑
t r < R C t_{r}<RC t r < RC R R R C C C
电阻寄生效应
导线上的电压降导致欧姆电压降,降低信号电平
解决方法:缩短电源引线端与电路的电源接线端的最大距离
解决RC延时的方法
采用更好的互连材料(电阻较低的铜或者低介电常数的介质)
对于存储器中的地址线
对角线布线
插入中继器(反相器或缓冲器),每段互连线长度缩短至 L m \frac{L}{m} m L
最优数目 m o p t = L 0.38 r c t p b u f = t p w i r e ( u n b u f f e r e d ) t p b u f m_{opt} = L \sqrt{\frac{0.38rc}{t_{pbuf}}} = \sqrt{\frac{t_{pwire(unbuffered)}}{t_{pbuf}}} m o pt = L t p b u f 0.38 rc = t p b u f t pw i re ( u nb u ff ere d ) t p b u f t_{pbuf} t p b u f t p , o p t = 2 t p w i r e ( u n b u f f e r e d ) t p b u f t_{p,opt}=2\sqrt{ t_{pwire(unbuffered)} t_{pbuf}} t p , o pt = 2 t pw i re ( u nb u ff ere d ) t p b u f
但上面的计算没有考虑负载电容
考虑负载电容之后:t p = m ( 0.69 R d s ( s γ C d + c L m + s C d ) + 0.69 ( r L m ) ( s C d ) + 0.38 r c ( L m ) 2 ) t_p = m \left( 0.69 \frac{R_d}{s} \left( s\gamma C_d + \frac{cL}{m} + sC_d \right) + 0.69 \left(\frac{rL}{m} \right) \left( sC_d \right) + 0.38rc \left(\frac{L}{m}\right)^2 \right) t p = m ( 0.69 s R d ( s γ C d + m c L + s C d ) + 0.69 ( m r L ) ( s C d ) + 0.38 rc ( m L ) 2 ) s s s R d R_{d} R d C d C_{d} C d γ \gamma γ m m m
对 m m m s s s
m o p t = L 0.38 r c 0.69 R d C d ( γ + 1 ) = t p w i r e ( u n b u f f e r e d ) t p 1 m_{opt}=L\sqrt{ \frac{0.38rc}{0.69R_{d}C_{d}(\gamma+1)} }=\sqrt{ \frac{t_{pwire(unbuffered)}}{t_{p_{1}}} } m o pt = L 0.69 R d C d ( γ + 1 ) 0.38 rc = t p 1 t pw i re ( u nb u ff ere d ) s o p t = R d c r C d s_{opt}=\sqrt{ \frac{R_{d}c}{rC_{d}} } s o pt = r C d R d c t p , m i n = ( 1.38 + 1.02 1 + γ ) L R d C d r c t_{p,min}=(1.38+1.02\sqrt{ 1+\gamma })L\sqrt{ R_{d}C_{d}rc } t p , min = ( 1.38 + 1.02 1 + γ ) L R d C d rc L c r i t = L m o p t − l o a d 1 = t p b u f f 1 0.38 r c L_{crit}=\frac{L}{m_{opt-load_{1}}}=\sqrt{ \frac{t_{pbuff_{1}}}{0.38rc} } L cr i t = m o pt − l o a d 1 L = 0.38 rc t p b u f f 1 t p , c r i t = t p , m i n − l o a d 1 m o p t = 7.9 t p 0 t_{p,crit}=\frac{t_{p,min-load_{1}}}{m_{opt}}=7.9t_{p_{0}} t p , cr i t = m o pt t p , min − l o a d 1 = 7.9 t p 0 最佳线长和延时与 L L L
如何看版图
connect: metal-diffusion / metal-pol
via: metal-metal
除了正常地看一些MOS版图,有一些比较复杂的版图可以这样看待:
对于黑色的contact,它的边长是 2 λ 2\lambda 2 λ 4 λ / 2 λ 4\lambda/2\lambda 4 λ /2 λ
Hspice
引用子电路首字母
Letter Element R Resistor C Capacitor L Inductor K Mutual Inductor V Independent voltage source I Independent current source M MOSFET D Diode Q Bipolar transistor W Lossy transmission line X Subcircuit E Voltage-controlled voltage source G Voltage-controlled current source H Current-controlled voltage source F Current-controlled current source
组合逻辑
互补CMOS
互补CMOS可以用来实现组合逻辑
NMOS串联相当于AND,并联相当于 OR
上拉下拉互为对偶网络
本质上是反相的,若想实现AND/OR/XOR需要加一级反相器
CMOS特性(静态)
全电压摆幅,高噪声容限
不依赖器件尺寸,无比例要求(无比逻辑)
总有通向 V d d V_{dd} V dd G N D GND GN D
零稳态输入电流,高输入阻抗
稳态无直流通路,无静态功耗
传播延迟取决于 C L C_{L} C L
计算delay:将MOS管看成含有开关的电阻,用 ln 2 R C \ln2RC ln 2 RC
对于复杂的上拉/下拉网络,常常需要让网络电阻的等效电阻和标准invertor的电阻相等,具体方法是改器件的尺寸(考虑最差情况,尤其是上拉网络 )(其目的是为了让充电/放电的电阻与minimum-sized invert相等)
为了方便计算:NMOS与PMOS较标准mos管的等效:
计算的结果与input的类型(low→high/high→low)有关
计算一个复杂电路的delay
首先找到上拉/下拉通路
之后找到其中每个节点的电阻/电容
用Elmore delay进行计算
propagation delay是最长的delay
contamination delay是最短的delay(可以预设提前放掉了电容上的电)
Fan in & Fan out 对 t p t_{p} t p
Fan in: 二次(电阻*电容)+线性
Fan out:线性(each additional fanout gate adds two gate caps to CL)
Fan in 比较大的时候,有哪些优化方法
Transistor reordering:重排序,把晚到达的信号安排在离输出更接近的地方
Progressive Size:逐级递增的尺寸,越靠近输出的管子尺寸越小
Alternative Logic Structures:用更小fan-in的门进行电路组合
Buffer Insertion:在fan out之前插入反相器做为buffer,来隔离fan in和fan out
逻辑门的延时
Gate delay: d = p + h = p + g ⋅ f d=p+h=p+g\cdot f d = p + h = p + g ⋅ f
p p p
NAND:p = n p=n p = n
NOR:p = n p=n p = n
MUX:p = 2 n p=2n p = 2 n
XOR/XOR(2输入):p = 4 p=4 p = 4
h h h g g g C g − l o g i c g a t e C g − i n v \frac{C_{g-logicgate}}{C_{g-inv}} C g − in v C g − l o g i c g a t e
NAND:g = n + 2 3 g=\frac{n+2}{3} g = 3 n + 2
NOR:g = 2 n + 1 3 g=\frac{2n+1}{3} g = 3 2 n + 1
MUX:2 2 2
XOR:n 2 n − 1 n2^{n-1} n 2 n − 1
f f f
f = C i + 1 C i f=\frac{C_{i+1}}{C_{i}} f = C i C i + 1 例题图示:
多级网络延时
分支努力:b = C o n − p a t h + C o f f − p a t h C o n − p a t h b=\frac{{C_{on-path}+C_{off-path}}}{C_{on-path}} b = C o n − p a t h C o n − p a t h + C o ff − p a t h
D = ∑ i = 1 N ( p i + g i ⋅ f i ⋅ b i ) = ∑ i = 1 N ( p i + h i ) = ∑ i = 1 N d i D = \sum_{i=1}^{N} (p_i + g_i \cdot f_i \cdot b_i) = \sum_{i=1}^{N} (p_i + h_i) = \sum_{i=1}^{N} d_i D = ∑ i = 1 N ( p i + g i ⋅ f i ⋅ b i ) = ∑ i = 1 N ( p i + h i ) = ∑ i = 1 N d i
h i = g i f i b i h_i = g_i f_i b_i h i = g i f i b i F = C o u t / C i n = ∏ f i F = C_{out} / C_{in} = \prod f_i F = C o u t / C in = ∏ f i D = ∑ d i = ∑ p i + ∑ h i D = \sum d_i = \sum p_i + \sum h_i D = ∑ d i = ∑ p i + ∑ h i 如果给了 x i x_{i} x i d i = p i + g i + 1 x i + 1 + x i + 1 ′ x i d_i = p_i + \frac{g_{i+1}x_{i+1} + x'_{i+1}}{x_i} d i = p i + x i g i + 1 x i + 1 + x i + 1 ′
x i x_i x i i i i x i + 1 x_{i+1} x i + 1 i + 1 i+1 i + 1 g i + 1 g_{i+1} g i + 1 i + 1 i+1 i + 1 x i + 1 ′ x'_{i+1} x i + 1 ′ C m i n − i n v C_{min-inv} C min − in v
优化:h N = G B F h^N=GBF h N = GBF
h = G B F N h = \sqrt[N]{GBF} h = N GBF 第 n n n
h N = h = g N b N f N = g N b N c N + 1 c N h_N = h = g_N b_N f_N = g_N b_N \frac{c_{N+1}}{c_N} h N = h = g N b N f N = g N b N c N c N + 1 c N = g N b N c N + 1 h c_N = g_N b_N \frac{c_{N+1}}{h} c N = g N b N h c N + 1
G = g 1 g 2 … g N G = g_1 g_2 \ldots g_N G = g 1 g 2 … g N B = b 1 b 2 … b N B = b_1 b_2 \ldots b_N B = b 1 b 2 … b N H = G F B = ∏ g i f i b i H = GFB = \prod g_i f_i b_i H = GFB = ∏ g i f i b i
Asymmetric Gates
某个输入比其他输入在电路中位置更重要的时候,可以用更小的管子进行优化,但是同一支路的总电阻不变(倒数加和为1或者2)
Skewed gates: The high-to-low and low-to-high propagation delays are not equal
z减小非关键管子的尺寸来优化电路
高偏斜门:有利于上升
低偏斜门:有利于下降
这里计算的逻辑努力需要区分上升/下降,注意与上升/下降效果一样的标准门进行比较
标准的一些门:
Power Analysis
Power Type Constant Throughput/Latency Variable Throughput/Latency Design Time(芯片设计阶段) Non-active Modules(芯片运行时,但某些特定的模块不工作) Run Time(系统根据当前的负载情况动态调整性能) Dynamic Active Factor(逻辑优化减少不必要的翻转)V d d V_{dd} V dd Clock Gating(门控时钟,直接切断该模块的时钟信号) DFS, DVS (Dynamic Freq, Voltage Scaling)(任务轻时,同时降低时钟频率和供电电压) Leakage Variable-V T V_T V T Sleep Transistors(不工作时,切断电源)V T V_T V T Variable V T V_T V T V T V_{T} V T V T V_{T} V T
Active Factor: P d y n = C L V D D 2 f 0 → 1 = C L V D D α 0 → 1 F P_{dyn}=C_{L}V_{DD}^2f_{0\to1}=C_{L}V_{DD}\alpha_{0\to1}F P d y n = C L V DD 2 f 0 → 1 = C L V DD α 0 → 1 F
α 0 → 1 = p 0 p 1 \alpha_{0\to1}=p_{0}p_{1} α 0 → 1 = p 0 p 1 0 0 0 p 0 p_{0} p 0 1 1 1 p 1 p_{1} p 1 输入相互独立并均匀分布,任何 N N N α 0 → 1 = N 0 2 N N 1 2 N \alpha_{0\to 1}= \frac{N_{0}}{2^N} \frac{N_{1}}{2^N} α 0 → 1 = 2 N N 0 2 N N 1
N 0 N_{0} N 0 N 1 N_{1} N 1
Reduce Switching Activity
Logic Restructuring:调整门电路连接结构,降低节点的开关活动率
Input Ordering:将概率最低的输入信号放在最前面,降低整个电路的功耗
Time-multiplexing resource:进行资源时分复用,利用信号之间的相关性(A为0时B为1,如果二者走一条线,就不会翻转)来降低翻转率
Glitch Reduction by balancing signal paths
当信号通路不平均时,会由于不同的门延时产生不必要的翻转,从而提升翻转率,可以通过平衡信号通路/插入buffer拉平延迟来降低翻转率
Varible V T V_{T} V T
inside a block
非关键路径移到比较低的电源电压(减慢速度但省功耗)
低电压和高电压交界处,需要插入电平转换器
Block-level
高吞吐量/低延迟的模块用较高的电源电压
较慢的功能模块用较低的电源电压
把相同电压的模块放在一起,独立供电,在模块边界处进行电平转换
shared N well为了节省面积,把高电压和低电压的PMOS管的衬底都连在偏高的电压上,减小了隔离间距和芯片面积,但产生了体效应,使低电压的管子变慢
高电压驱动低电压的门是安全的,但低电压驱动高电压的门是坏的(会导致后级高电压门出现两管均导通的现象),需要用电平转换器来调整电压
Clock Gating:用锁存器生成disable signal,切断空闲时对应模块的时钟信号
Dynamic voltage and frequecy scaling
多阈值电压
混合使用不同阈值的晶体管,低阈值的晶体管速度快但漏电多,用于关键路径;高阈值的晶体管速度慢但漏电少,用于非关键路径
通过利用体效应改变阈值电压
正向体偏置:降低阈值电压绝对值 ,提升运行速度(降低阈值电压可以增大mos管源漏之间的电流,从而提高对负载充放电的速度)
反向体偏置:提升阈值电压绝对值,抑制漏电
也可以利用堆叠效应(由DIBL效应,源漏电压会造成阈值电压的变化,源漏电�压越高,阈值电压越小)降低漏电流
将晶体管堆叠在一起之后,源漏电压减小,从而可以降低漏电流
Sleep Transistors/Power Gating
消除不工作模块的静态漏电,在电源/地和电路之间串联巨大的开关管
在断电的模块和之后的模块之间必须加入隔离单元,防止浮空节点造成输出漂移
开关管
NMOS 或者 PMOS
其中NMOS管由于是电子导电较PMOS更省面积
用高阈值电压的管子防止自身漏电
双开关管漏电最低
有比逻辑(Ratioed Logic)
相比于互补CMOS(需要2N个管子),有比逻辑试图减少晶体管数量(通常是N+1个)。
减少了器件数量,面积小,通常速度快(因为负载电容小)。
牺牲了鲁棒性(噪声容限降低)并且存在静态功耗(Static Power Dissipation)。
负载类型
电阻负载
V O L = R P N R P N + R L V D D V_{OL}=\frac{R_{PN}}{R_{PN}+R_{L}}V_{DD} V O L = R PN + R L R PN V DD 大电阻:降低 V O L V_{OL} V O L t p L H t_{pLH} t p L H
小电阻:翻转速度快,但 V O L V_{OL} V O L
耗尽型负载(V T < 0 V_{T}<0 V T < 0
伪NMOS负载(Pseudo-NMOS)
栅极接地的PMOS代替电阻,前提是下拉网络比PMOS更强
V O L V_{OL} V O L V I L V_{IL} V I L V t n V_{tn} V t n 面积小,负载小,但是有静态功耗
计算 V O L ≈ k p ( − V D D − V T p ) ⋅ V D S A T k n ( V D D − V T n ) ≈ μ p ⋅ W p μ n ⋅ W n ⋅ ∣ V D S A T ∣ ( assuming that V T n = ∣ V T p ∣ ) V_{OL} \approx \frac{k_p(-V_{DD} - V_{Tp}) \cdot V_{DSAT}}{k_n(V_{DD} - V_{Tn})} \approx \frac{\mu_p \cdot W_p}{\mu_n \cdot W_n} \cdot |V_{DSAT}| \quad (\text{assuming that } V_{Tn} = |V_{Tp}|) V O L ≈ k n ( V DD − V T n ) k p ( − V DD − V Tp ) ⋅ V D S A T ≈ μ n ⋅ W n μ p ⋅ W p ⋅ ∣ V D S A T ∣ ( assuming that V T n = ∣ V Tp ∣ )
计算逻辑努力
净下拉电流 = NMOS下拉电流 - PMOS上拉电流
用净下拉电流与给到同样下拉电流的标准的invertor进行计算,可以得到 g d g_{d} g d
用PMOS上拉电流与给到同样上拉电流的标准的invertor进行计算,可以得到 g u g_{u} g u
计算 p u p_{u} p u p d p_{d} p d
与CMOS相比,NAND更慢,NOR更快,且对于NOR,逻辑努力与input的个数无关,因此伪NMOS负载特别适合做宽口径的NMOS门
其他组合逻辑
差分串联电压开关逻辑(DCVSL):解决了伪NMOS有静态功耗的问题,且降低 V O L V_{OL} V O L
传输管逻辑(Pass-Transistor Logic)相比CMOS可以减小功耗,面积以及延时
基本模块:
由于PMOS/NMOS的导通限制,NMOS只能传输强0信号,PMOS只能传输强1信号
传输管的输出不能连在下一级的栅极上(也是由于导通必须要 V G S > V T V_{GS}>V_{T} V GS > V T
对于NMOS only的这类电路,NMOS需要的切换能量更小,同时产生的弱1会导致下一级电路出现漏电流
互补传输管逻辑(Complemetntary Pass Transistor Logic/Differential Pass Transistor Logic)
主要思路是用MUX的公式 F = A ⋅ S + B ⋅ S ˉ F=A\cdot S+B\cdot \bar{S} F = A ⋅ S + B ⋅ S ˉ A / B A/B A / B
这种设计非常模块化,使得设计电路库非常方便
但是仍然会出现信号在传播中下降的现象
Level Restoring Transistor:
带来全摆幅输出
M r M_{r} M r
改进:SRPL
transistor的管子用0或低阈值的晶体管
但仍然带来问题,因为 V S V_{S} V S 1 1 1
使用传输门
传输门的电阻取决于 V i n V_{in} V in V o u t V_{out} V o u t
可以做到全摆幅传输
传输门XOR
计算传输门的延时:直接用传输门的等效电阻取代传输门
τ ( V n ) = ∑ k = 0 n C R e q k = C R e q n ( n + 1 ) 2 \tau(V_n) = \sum_{k=0}^{n} CR_{eq}k = CR_{eq}\frac{n(n+1)}{2} τ ( V n ) = ∑ k = 0 n C R e q k = C R e q 2 n ( n + 1 ) 对传输门的延时进行优化:
Dynamic Logic Gate
与静态电路的区别:依赖于将信号值暂时存储在高阻抗节点的电容上,于CMOS相(n n n 2 n 2n 2 n n n n n + 2 n+2 n + 2
有两个phase,预充电phase和求值phase
优点
晶体管数更少
输入信号少驱动了PMOS,使前一级的输入电容减半,降低负载电容
减小了输出节点的寄生电容
(由于负载电容变小)速度更快
全输出摆幅
无比逻辑
没有静态功耗
缺点
总体功耗高于静态CMOS
vdd和gnd之间没有静态路径
无毛刺
有更高的翻转率
α 0 → 1 = N 0 2 N \alpha_{0\to1}=\frac{N_{0}}{2^N} α 0 → 1 = 2 N N 0
时钟带来额外负载
需要预充电
一旦动态门的输出被放电,在下一次预充电操作之前无法再次充电
输入如果从高电平到低电平,则输出端无法检测到这样的变化
V M V_M V M V I H V_{IH} V I H V I L V_{IL} V I L V T n V_{Tn} V T n N M L = V I L − V O L NM_L = V_{IL} - V_{OL} N M L = V I L − V O L
如果时钟在低��电平时,输入拉高,则会发生竞争
由于预充电并不是关键路径,可以缩小预充电晶体管的尺寸,使其有效电阻为下拉网络的两倍
计算逻辑努力:只考虑下拉网络的,思路一致:根据产生与单位反相器相同的电流的晶体管尺寸进行计算
带来的问题
Charge Leakage:即使下拉的这些NMOS都关闭,但也难免有漏电流(主要来自反偏二极管泄漏和亚阈值导通),输出电压遂时间下降,最终稳定在一个中间电压值(形成了由上拉电阻和下拉电阻组成的分压器)
解决方案:使用电压保持器(Keeper)
注意需要做得比较弱,因为它会跟下拉网络竞争电流
如果这个管子size比较大,那么抗噪声能力会更好,但会带来速度下降,功耗增加,更难被拉低这样的问题
设计方法:
增大管子沟道长度,但这会增加栅极电容,从而增加负载
串联两个最小尺寸的管子,可以更灵活地调整等效电阻
Charge Sharing:在CLK=0的时候,电荷在内部节点和输出节点上进行分享,导致输出节点上的电平降低
计算:具体用那种方法,其实取决于 C L C_{L} C L C a C_{a} C a V D D − V T n V_{DD}-V_{Tn} V DD − V T n M a M_{a} M a V D D V_{DD} V DD
Δ V o u t > − V T n \Delta V_{out} > -V_{Tn} Δ V o u t > − V T n C L C_{L} C L V T n V_{Tn} V T n Δ V o u t = − C a C L [ V D D − V T n ( V X ) ] \Delta V_{out} = -\frac{C_a}{C_L} [V_{DD} - V_{Tn}(V_X)] Δ V o u t = − C L C a [ V DD − V T n ( V X )] Δ V o u t < − V T n \Delta V_{out} < -V_{Tn} Δ V o u t < − V T n C a C_a C a C L C_L C L V o u t V_{out} V o u t V D D − V T n V_{DD} - V_{Tn} V DD − V T n C L V D D = ( C L + C a ) V f i n a l C_L V_{DD} = (C_L + C_a) V_{final} C L V DD = ( C L + C a ) V f ina l
解决方案:使用次级预充电晶体管 (secondary precharge transistors)对部分或所有内部节点进行预充电来克服电荷分享问题。
Backgate Coupling
在动态电路与静态电路的接口处,动态信号(快速的电压变化)通过栅极电容耦合回电路的其他部分,导致后续电路出现噪声
把动态电路的输出连到静态门最下面(如果是 NMOS)或最上面(如果是 PMOS)的管子(驱动outer inputs)
Clock Feedthrough
CLK和Out之间的寄生电容使得Out电压可能会升到V D D V_{DD} V DD
时钟的快速上升/下降沿会耦合到Out产生噪声
示意图
多级电路的解决方案:Domino Gates
优点:比CMOS快1.5到2倍
缺点:噪声能力弱,存在电荷分享,有电流泄露,以及单调性
在动态级之后接一个反相的静态门,产生单调(0→1)的输出
本质上是非反相的,只能实现正逻辑
可以添加额外的反相器
也可以级联动态门,不用中间的反相器
对后一级的时钟信号进行延迟,确保上一级的求值已经结束
每一级必须有Foot transistor
使用Dual-Rail Domino
产生互补的输出
对于多级多米诺逻辑,如果在后面几级precharge阶段input都等于0,那么Foot transistor可以被删掉
特别的,如果后面几级多米诺逻辑没有引入外部输入,那么后面几级都是footless的
想要省去中间的静态反相器,可以使用 NP Dynamic CMOS
动态使用两种类型的动态门
PDN输入只允许使输出1→0的输入,PUN输入只允许使输出0→1的输入
缺点:P 型动态逻辑块依赖 PMOS 进行逻辑求值。由于空穴迁移率低,PMOS 通常比 NMOS 慢,导致整体电路速度变慢,或者为了匹配速度需要将 PMOS 做得很大,增加了面积。
用于紧凑电路的多输出多米诺逻辑,将多个计算合并到一个单一的输出门中来增加面积,例如加法器:
左下角的图合并了上面几张图的电 路结构,并用预充电器件进行充电
数据通路
对于数字IC设计而言,其结构主要分为以下几个部分
arithmetic unit
memory
control unit
interconnect
Adders(属于arithmetic unit)
通常做为关键路径,限制了整个电路的速度
设计优化
逻辑:利用布尔方程来实现更快/更小的电路
电路:调整晶体管尺寸和电路拓扑结构来优化速度
Full Adder
输入 A A A B B B C i C_{i} C i S S S C o C_{o} C o
S = A ⊕ B ⊕ C i S=A \oplus B \oplus C_i S = A ⊕ B ⊕ C i C o = A B + ( A + B ) C i C_{o}=AB+(A+B)C_{i} C o = A B + ( A + B ) C i 转换一下,让 S S S C o C_{o} C o
S = A B C i + C o ˉ ( A + B + C i ) S = ABC_i + \bar{C_o}(A + B + C_i) S = A B C i + C o ˉ ( A + B + C i ) CMOS表示:
缺点:
面积大(28T)
负载中:输出信号连下一级全加器要连6个晶体管的栅极
延迟长: C i C_{i} C i C o C_{o} C o
优点:
从 C i C_{i} C i C o C_{o} C o
控制 C i C_{i} C i C i C_{i} C i A A A B B B
对于全加器,所有输入反相相当于所有输出反相,利用这一点可以简化逻辑,在实际搭电路的时候适当把输入反相,来获得输出交替为正相/反相的效果(奇偶交替)
Original Ripple-Carry Adder
把全加器级联
N N N t a d d e r = ( N − 1 ) t c a r r y + t s u m t_{adder}=(N-1)t_{carry}+t_{sum} t a dd er = ( N − 1 ) t c a rry + t s u m
Mirror Adder
利用全加器反相特性省去两个反相器
优势:信号完整性强,输出电压可以达到满摆幅,无阈值电压损失,噪声容限高,电路稳定性与抗干扰能力出色,驱动能力强
劣势:面积较大,延迟较高,逻辑路径中反相器与门电路的级数较多
XOR full adder
CPL full adder
优势:晶体管数量少,面积小,延迟低
劣势:阈值电压损失,驱动能力弱需要外加缓冲器
RCA Adder/Subtractor(既做加法又做减法)
用 A + B ˉ + 1 A+\bar{B}+1 A + B ˉ + 1 A − B A-B A − B
优点:逻辑简单,成本低
缺点
速度慢,依然是行波进位模式
延迟高(延迟与位数成正比)
功耗大,中间的加法器会在最终稳定前多次翻转状态,并产生毛刺,带来无效功耗
内部信号
进位产生G = A B G=AB G = A B
进位传播P = A ⊕ B P=A\oplus B P = A ⊕ B
进位消除D / K = A ˉ B ˉ D/K=\bar{A}\bar{B} D / K = A ˉ B ˉ
C o = G + P C i C_o=G+PC_{i} C o = G + P C i S = P ⊕ C i S=P\oplus C_{i} S = P ⊕ C i
曼彻斯特进位链
观察到上述进位信号是互斥的,则可以根据上述信号的实际含义与互斥的属性设计出电路:
用Elmore Delay模型建模,得到延迟的公式:t p = 0.69 ∑ i = 1 N C i ( ∑ j = 1 i R j ) = 0.69 N ( N + 1 ) 2 R C t_p = 0.69 \sum_{i=1}^{N} C_i (\sum_{j=1}^{i} R_j)= 0.69 \frac{N(N+1)}{2} RC t p = 0.69 ∑ i = 1 N C i ( ∑ j = 1 i R j ) = 0.69 2 N ( N + 1 ) RC N N N
最长的曼彻斯特进位链大约是4
组进位
将单位的 p p p q q q
G i : j = G i : k + P i : k G k − 1 : j G_{i:j} = G_{i:k} + P_{i:k}G_{k-1:j} G i : j = G i : k + P i : k G k − 1 : j i ∼ k i\sim k i ∼ k P i : j = P i : k P k − 1 : j P_{i:j} = P_{i:k}P_{k-1:j} P i : j = P i : k P k − 1 : j G 0 : 0 = G 0 = C i n G_{0:0}=G_{0}=C_{in} G 0 : 0 = G 0 = C in P 0 : 0 = P 0 = 0 P_{0:0}=P_{0}=0 P 0 : 0 = P 0 = 0 C i − 1 = G i − 1 : 0 C_{i-1}=G_{i-1:0} C i − 1 = G i − 1 : 0 G G G C C C
如果一组之内的 P P P C i C_{i} C i C o C_{o} C o
4bit行波进位(用了PG Logic)
什么是阶数(Valency):一个逻辑门能同时处理几个进位输入
使用高阶Cells可以大大减小树的级数
eg:G i : j = G i : k + P i : k ( G k − 1 : l + P k − 1 : l ( G l − 1 : m + P l − 1 : m G m − 1 : j ) ) G_{i:j} = G_{i:k} + P_{i:k}(G_{k-1:l} + P_{k-1:l}(G_{l-1:m} + P_{l-1:m}G_{m-1:j})) G i : j = G i : k + P i : k ( G k − 1 : l + P k − 1 : l ( G l − 1 : m + P l − 1 : m G m − 1 : j ))
PG Diagram
黑色的cell代表既计算进位产生 G G G P P P
灰色的cell代表只计算进位产生 G G G
白色的三角缓冲器代表信号增强或对齐
图示
Carry-Ripple
Carry-Skip/Carry-Bypass
通过可变分组去减少逻辑层级
Carry Select
Carry Inc
B-tree
S-Tree
K-Tree
Architecture 介绍 时延公式 Classification Logic Levels Max Fanout Tracks Cells Carry-Ripple t r i p p l e = t p g + ( N − 1 ) t A O + t x o r t_{ripple} = t_{pg} + (N-1)t_{AO} + t_{xor} t r i ppl e = t p g + ( N − 1 ) t A O + t x or t p g t_{pg} t p g t A O t_{AO} t A O t x o r t_{xor} t x or S = P ⊕ C i S=P\oplus C_{i} S = P ⊕ C i N-1 2 1 N Carry-Skip/Carry-Bypass 组传播信号为1的时候,MUX选择组进位输入;为0时,选择串行进位加法器的进位输出 t s k i p = t p g + 2 ( n − 1 ) t A O + ( k − 1 ) t m u x + t x o r t_{skip} = t_{pg} + 2(n-1)t_{AO} + (k-1)t_{mux} + t_{xor} t s ki p = t p g + 2 ( n − 1 ) t A O + ( k − 1 ) t m ux + t x or t p g t_{pg} t p g P P P G G G t A O t_{AO} t A O t m u x t_{mux} t m ux n n n k k k N/4 + 5 3 1 1.25N Carry-Select 分别计算进位输入为0和1的结果,然后根据真正的进位信号用多路选择器选通 t s e l e c t = t p g + [ n ( 第一组的位数 ) + ( k − 2 ) ( 中间的 m u x ) ] t A O + t m u x t_{select} = t_{pg} + [n(第一组的位数) + (k-2)(中间的mux)]t_{AO} + t_{mux} t se l ec t = t p g + [ n ( 第一组的位数 ) + ( k − 2 ) ( 中间的 m ux )] t A O + t m ux Carry-Inc. n=4 先假设没有进位,把结果算出来。如果后来发现真的有进位,我再给结果加 1(递增) n n n k k k t i n c r e m e n t = t p g + [ ( n − 1 ) + ( k − 1 ) ] t A O + t x o r t_{increment} = t_{pg} + [(n-1) + (k-1)]t_{AO} + t_{xor} t in cre m e n t = t p g + [( n − 1 ) + ( k − 1 )] t A O + t x or N/4 + 2 5 1 2N Brent-Kung (L-1, 0, 0) 2log₂N - 1 2 1 2N Sklansky (0, L-1, 0) log₂N N/2 + 1 1 0.5 Nlog₂N Kogge-Stone (0, 0, L-1) log₂N 2 N/2 Nlog₂N
如何计算最大扇出:在某一级的逻辑门输出端,需要驱动下一级多少个逻辑门的输入端。
最大跨度(Track):在加法器的任意两级逻辑层之间,横向布线 最拥挤的地方,同时并行通过了多少根线。
补充
Carry Select Adder
线性进位选择加法器(Linear Carry Select Adder)
计算是并行的,但进位信号的选择是串行的, t t t
平方根进位选择加法器(Square Root Carry Select Adder)
为了不让后面的bit空等,采用可变分组大小
总位数 N N N N = 2 + 3 + 4 + ⋯ + ( P + 1 ) N = 2 + 3 + 4 + \dots + (P+1) N = 2 + 3 + 4 + ⋯ + ( P + 1 ) N ≈ ∑ i = 1 P i = P ( P + 1 ) 2 N \approx \sum_{i=1}^{P} i = \frac{P(P+1)}{2} N ≈ ∑ i = 1 P i = 2 P ( P + 1 ) P ≈ 2 N P \approx \sqrt{2N} P ≈ 2 N
整个加法器的延迟主要取决于信号穿过这一串 MUX 的时间。因为 MUX 的数量是 P,所以延迟与 P 成正比。
延迟是 O ( N ) O(\sqrt{ N }) O ( N )
Carry-Increment Adder
可变分组大小
同上:t i n c r e m e n t = t p g + 2 N t A O + t x o r t_{increment} = t_{pg} +\sqrt{ 2N }t_{AO} + t_{xor} t in cre m e n t = t p g + 2 N t A O + t x or
下图带buffer,延迟非关键路径的信号(为了防止信号竞争)
树型加法器分类:评估不同树型加法器在面积、速度、驱动能力之间的权衡
对于N位加法器有以下理想模型:
逻辑层级(延迟) L = log 2 N L = \log_2 N L = log 2 N
扇出(Fanout) ≤ 2 \le 2 ≤ 2
布线轨道(Wire Tracks) ≤ 1 \le 1 ≤ 1
但实际上,所有的树形加法器都受限于公式:λ + f + t = L − 1 \lambda + f + t = L - 1 λ + f + t = L − 1
实际层级 = L + λ L + \lambda L + λ
实际扇出 = 2 f + 1 2^{f+1} 2 f + 1
实际轨道 = 2 t 2^t 2 t
从这个角度看前面提到的三个tree
B:面积优化型,布线最少 (Track=1),扇出小,逻辑层级多,速度最慢。
S:逻辑深度优化型,逻辑层级最少,布线少,扇出极大 (Fanout高),导致电气性能差。
K:速度优化型,逻辑层级最少,扇出小,理论速度最快,布线极复杂 (Track多),面积最大,功耗高
除此之外,在实际应用中,还存在一些tree在三个tree之间,使用混合架构。
Timing/Sequential Circuits
组合逻辑:输出取决于此刻的输入
时序逻辑:输出取决于此刻和之前的输入
Latch:当clk拉高的时候,把输入D传送到输出Q
Register:当clk上升沿的时候,存储D
时序电路:在一大块组合逻辑之中适当插入register/latch
一些延迟
t c d t_{cd} t c d t p d t_{pd} t p d 对于Latch和FF而言
t s e t u p t_{setup} t se t u p t h o l d t_{hold} t h o l d
这些时序开销减少了可用的计算时间
因此有了一些延时约束,如果不满足这些约束,会带来建立时间约束or最大延时违例
T c ≥ t p c q ( F F 的传播延迟 ) + t p d + t s e t u p T_{c}\geq t_{pcq}(FF的传播延迟)+t_{pd}+t_{setup} T c ≥ t p c q ( FF 的传播延迟 ) + t p d + t se t u p t p c q t_{pcq} t p c q
违反这个约束会带来sequence overhead
改进方法
修改逻辑,让传播延迟变得更小
提高时钟周期
加入流水线,通过加register切开组合逻辑,从而让电路满足时序约束
t c c q + t c d ≥ t h o l d t_{ccq}+t_{cd}\geq t_{hold} t cc q + t c d ≥ t h o l d
违反这个约束会带来hold time failure, or min-delay failure
意思是说,在前面数据受clk影响改变的时间至少要大于保持时间,不然后续数据会因为小于保持时间被污染
改进方法:重新设计逻辑
在芯片中,如何把时钟信号传递到芯片的每一个角落?使用时钟树,例如:H-Tree
使用分形结构,可以将时钟信号送达至芯片上任意位置(任意精细的区域),所有路径上的延迟是相等的,但延迟的变动(由工艺、电压、温度等引起)会导致时钟偏斜。
Clock Skew(时钟偏斜)
空间上两个不同点处时序上等同的两个时钟沿在到达时间上的偏差
由时钟路径上的失配及时钟负载上的差别引起,取决于数据与时钟布线的方向,时钟偏差可正可负
具有确定性(时不变)
只会引起相移
δ ( i , j ) = t i − t j \delta(i,j)=t_{i}-t_{j} δ ( i , j ) = t i − t j Positive Skew:
T c + δ ≥ t p c q + t p d + t s e t u p T_{c}+\delta\geq t_{pcq}+t_{pd}+t_{setup} T c + δ ≥ t p c q + t p d + t se t u p δ + t h o l d < t c c q + t c d \delta+t_{hold}<t_{ccq}+t_{cd} δ + t h o l d < t cc q + t c d
Negative:正改负即可
如果一个时序逻辑电路带有反馈(数据流向与时钟流向相反),会改变时钟偏斜的正负
同一个电路系统中,可能同时存在正偏斜约束和负偏斜约束
组合逻辑内部的关键路径是随输入状态变化的
Clock Jitter:空间上同一个点处时钟周期随时间的变化
平均值为零的随机变量
绝对抖动 (Absolute jitter, t j i t t e r t_{jitter} t ji tt er
周期至周期抖动 (Cycle-to-cycle jitter, T j i t t e r T_{jitter} T ji tt er
加入绝对抖动之后,时钟约束变为:
t h o l d + δ + 2 t j i t t e r ≤ t c c q + t c d t_{hold} + \delta + \mathbf{2t_{jitter}} \le t_{ccq} + t_{cd} t h o l d + δ + 2 t jitter ≤ t cc q + t c d T + δ − 2 t j i t t e r ≥ t p c q + t p d + t s e t u p T + \delta - \mathbf{2t_{jitter}} \ge t_{pcq} + t_{pd} + t_{setup} T + δ − 2 t jitter ≥ t p c q + t p d + t se t u p 总之是让约束变得更紧了
positive skew:上界宽松下界紧,nagetive相反;jitter:两边都收紧x2倍(这里指的是组合逻辑的上下界)
时钟抖动和时钟偏斜的来源
时钟生成
器件工艺偏差
互连线
电源
温度
电容负载
邻近线路的耦合

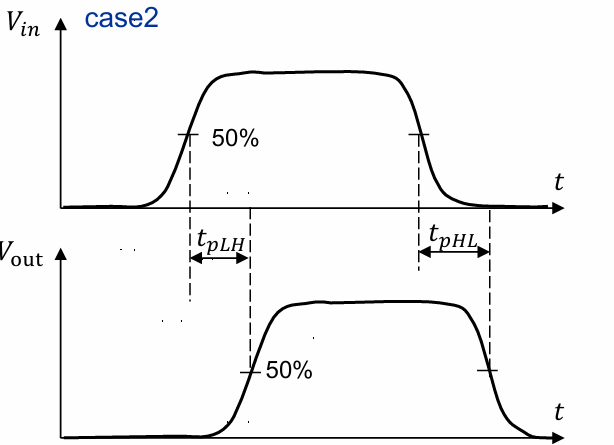

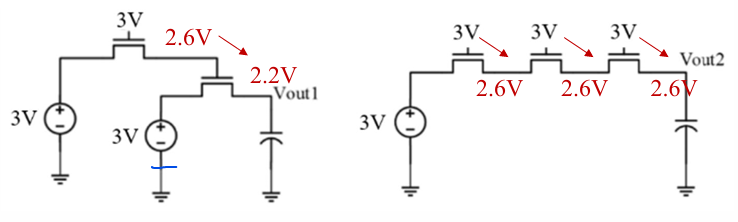
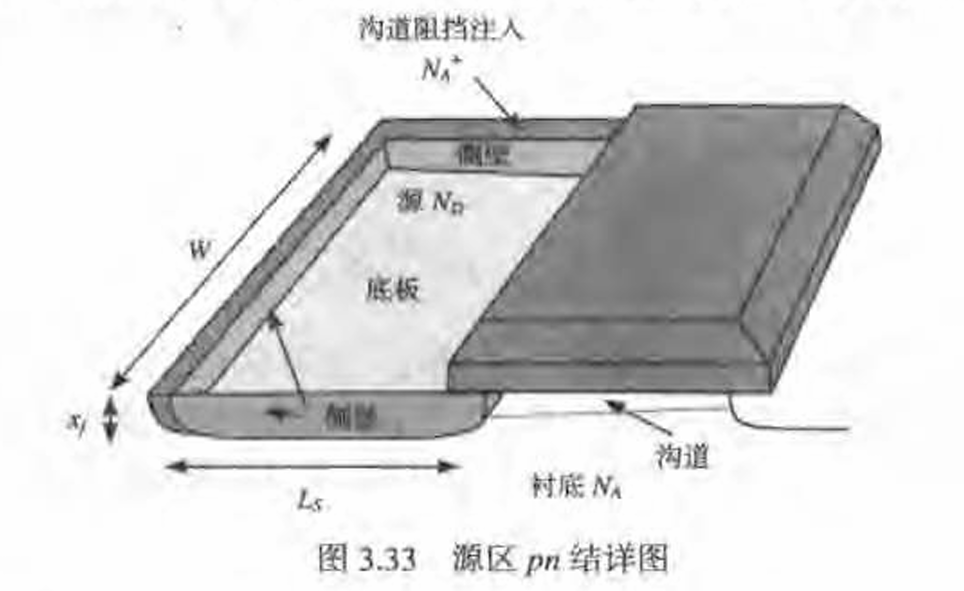
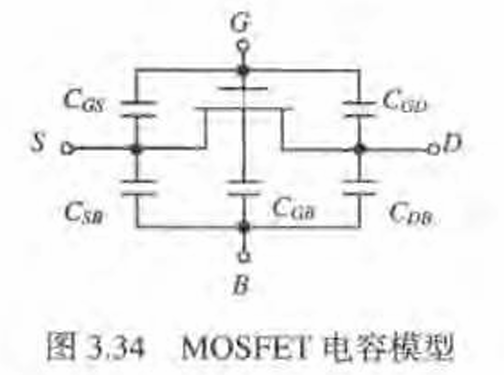

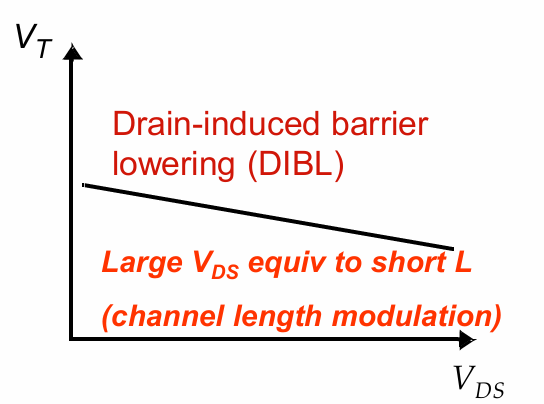

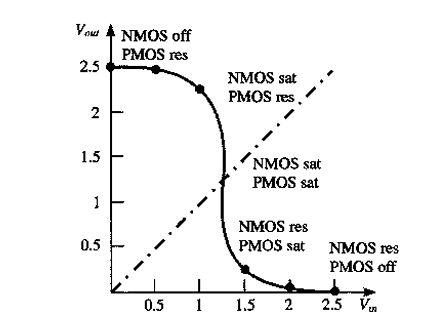

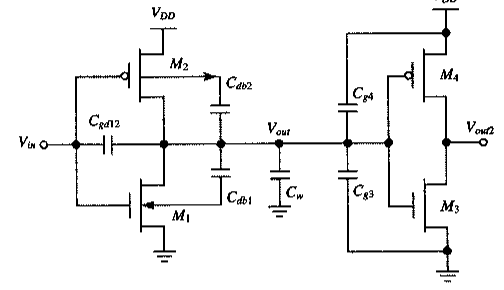




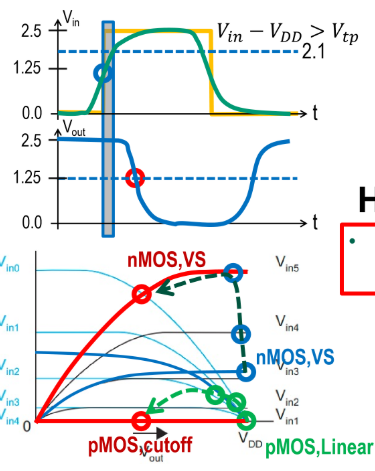




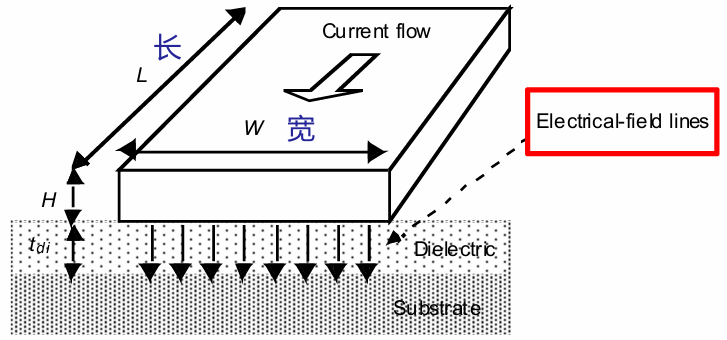 其中 ,为绝缘层材料介电系数
其中 ,为绝缘层材料介电系数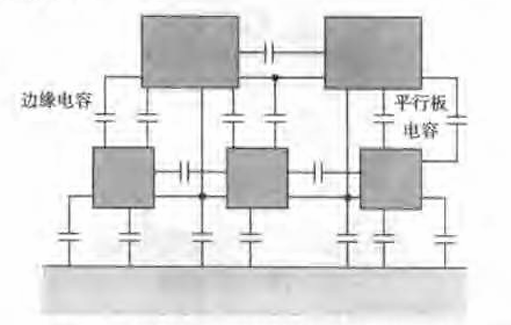 上图中可以用 来表示,随着器件缩小,主要的电容是interwire电容
上图中可以用 来表示,随着器件缩小,主要的电容是interwire电容 这类计算题还需要注意的是计算边缘电容时要×2
这类计算题还需要注意的是计算边缘电容时要×2 每单位长度电阻的表达式
每单位长度电阻的表达式 


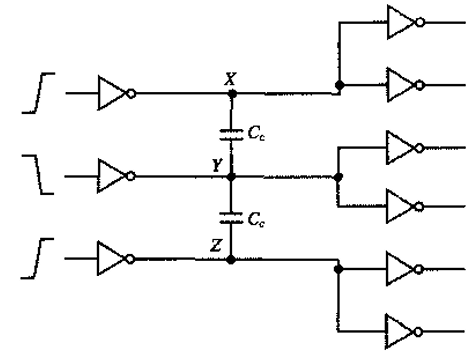



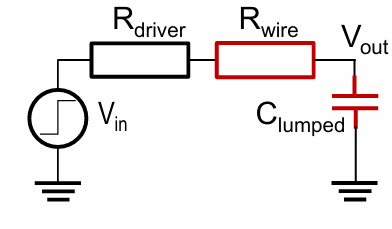
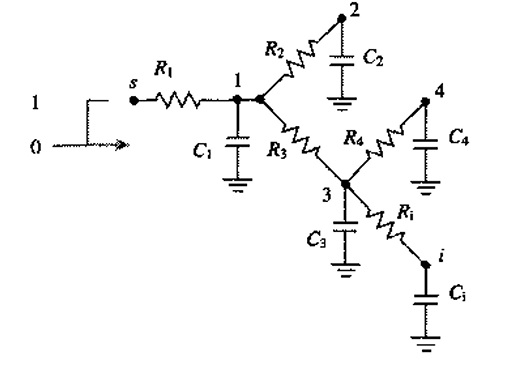
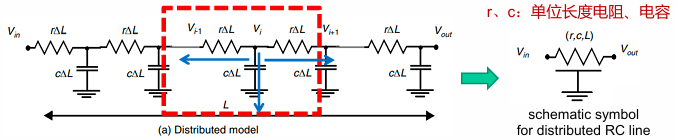
 有
有


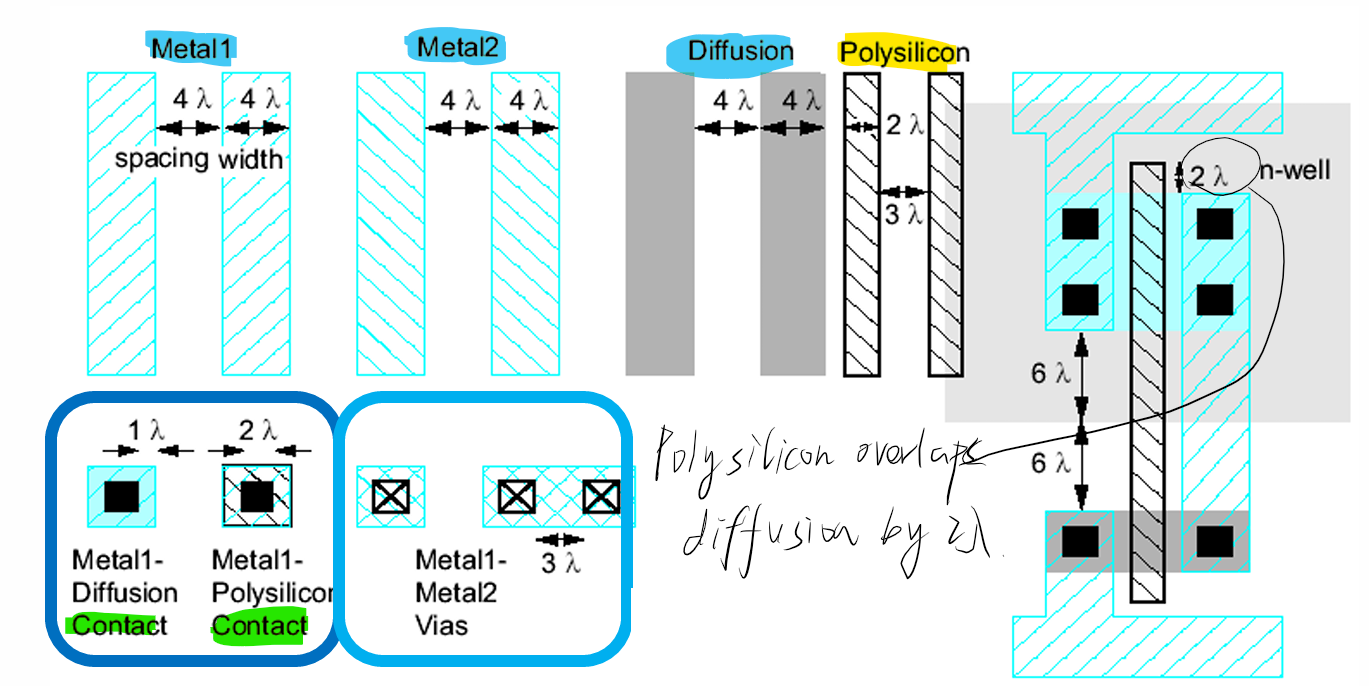
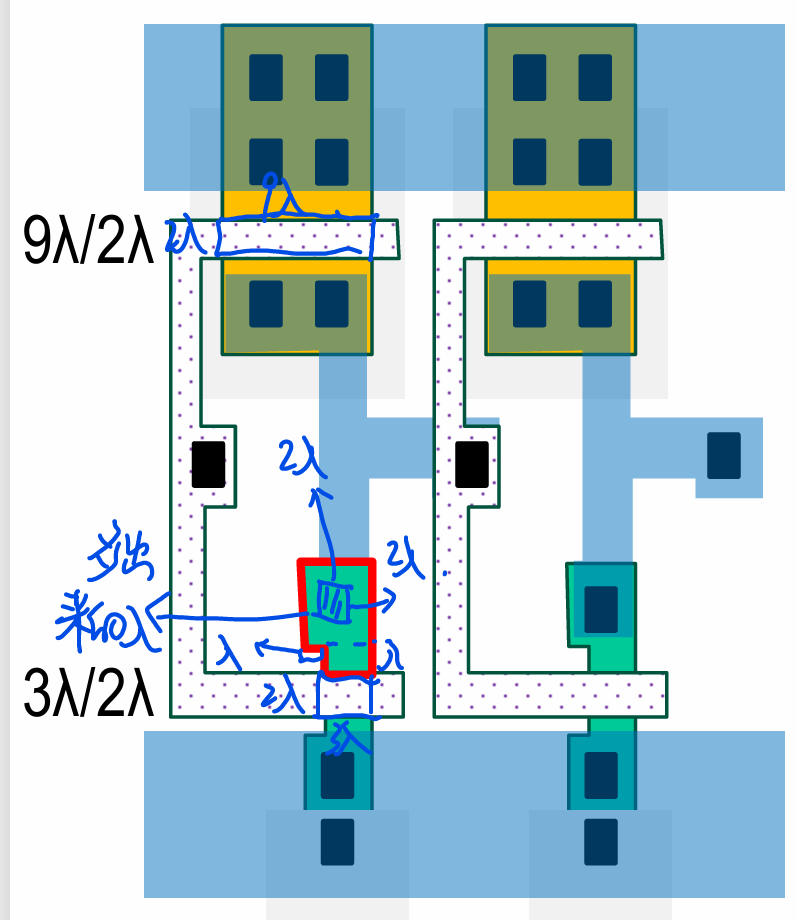 对于MOS门,经常用Width/Length来表示。
最小的size是 ,一般称作1个unit(我们可以从接触孔尺寸中看出这一点)
这种曲里拐弯的可以这样看
对于MOS门,经常用Width/Length来表示。
最小的size是 ,一般称作1个unit(我们可以从接触孔尺寸中看出这一点)
这种曲里拐弯的可以这样看
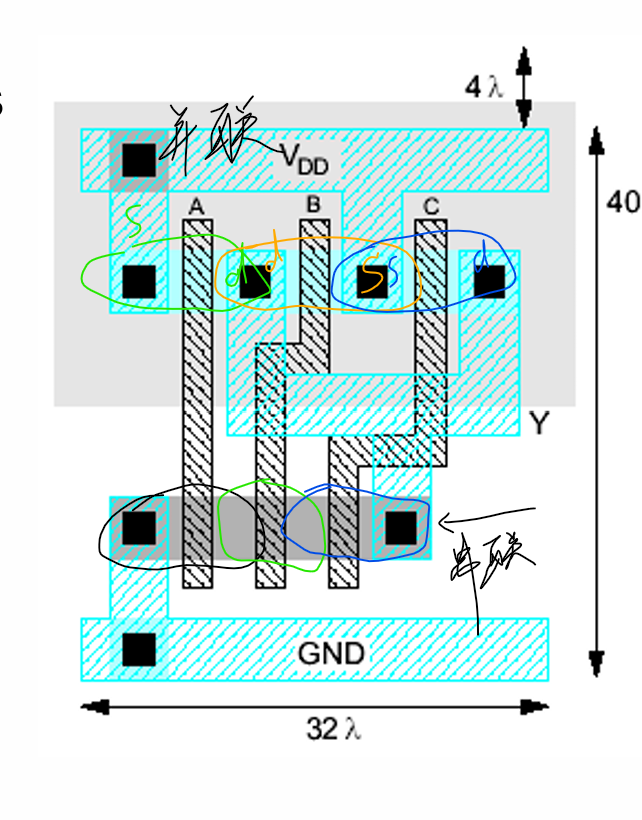
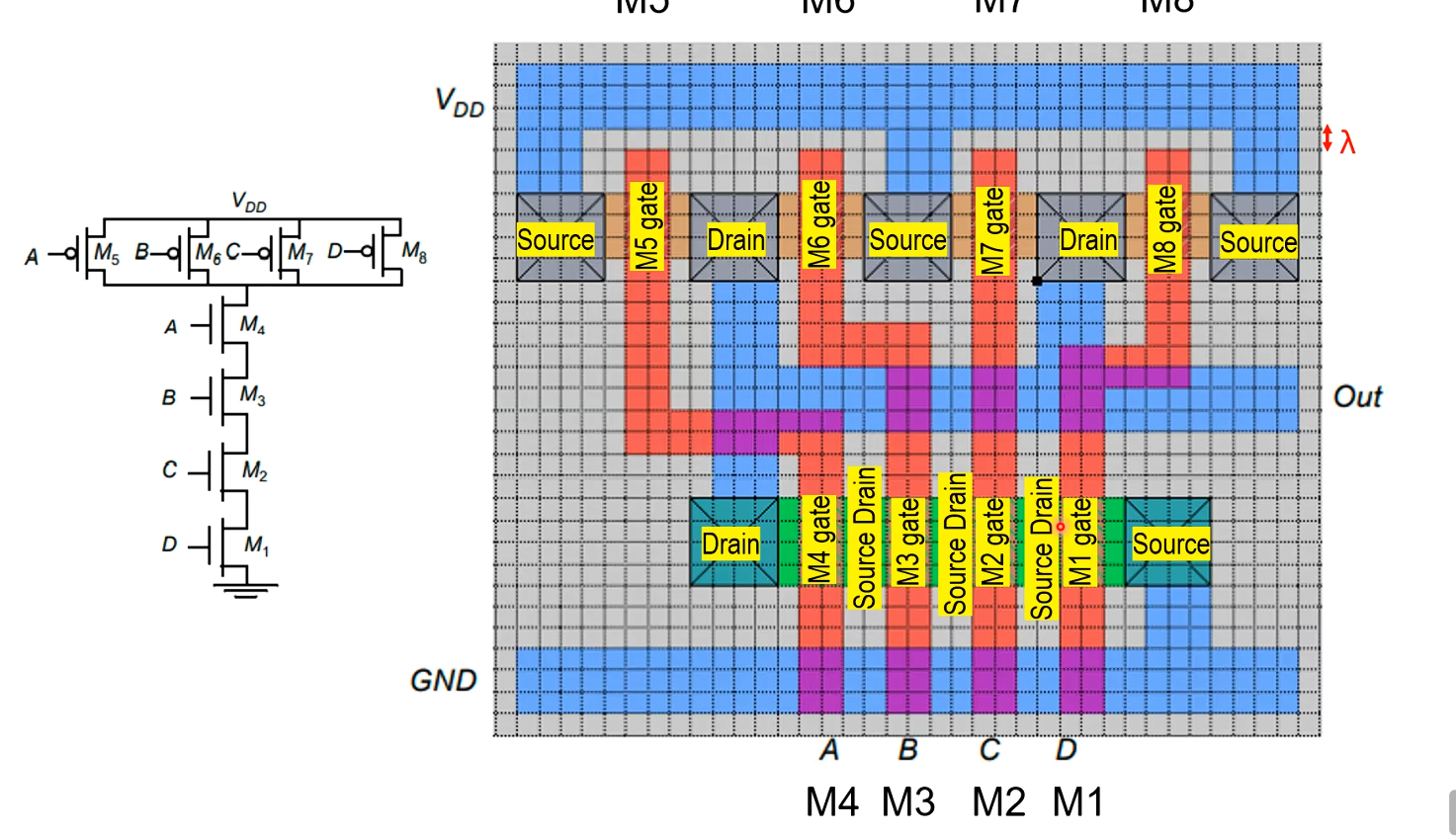
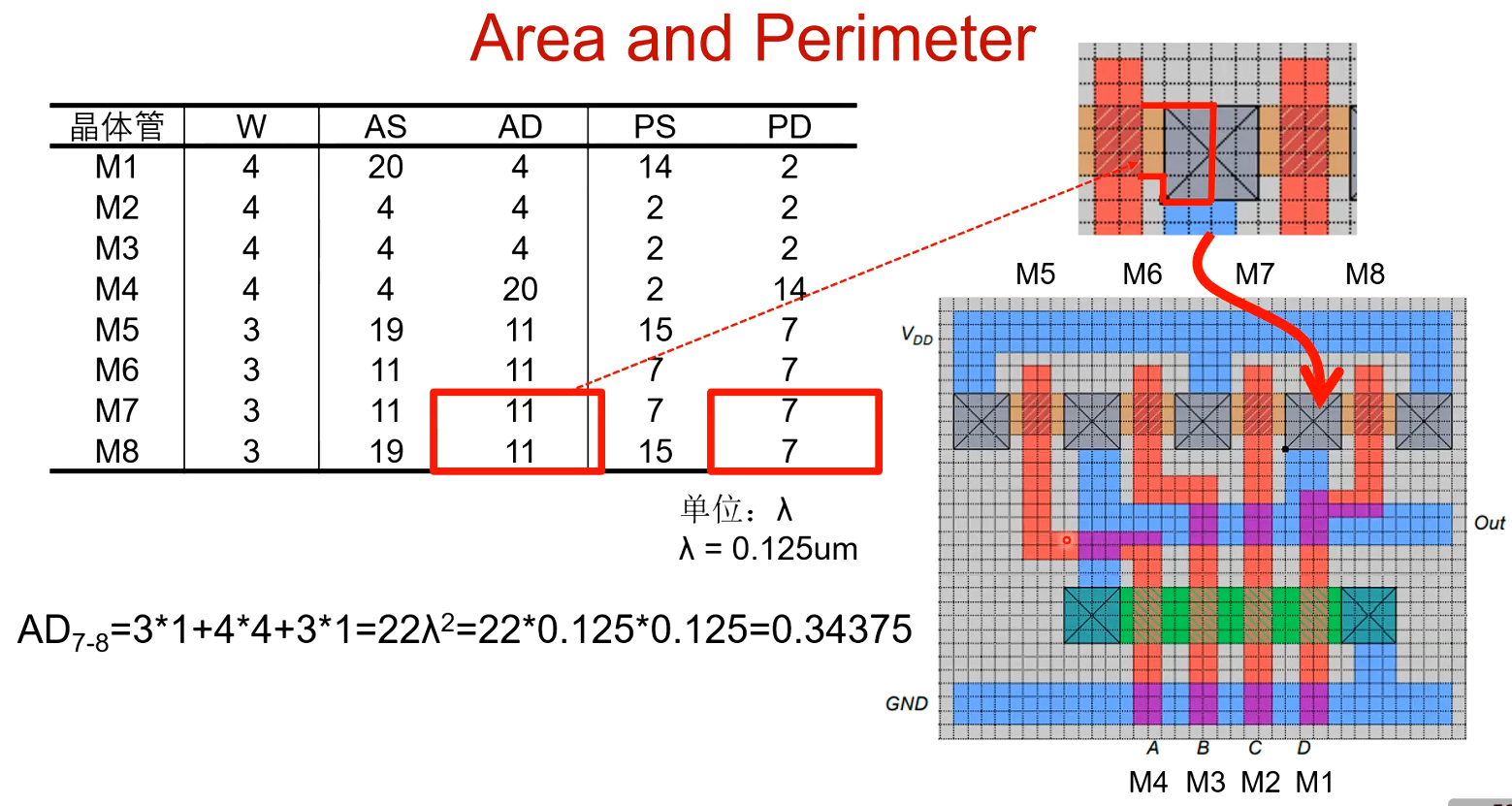
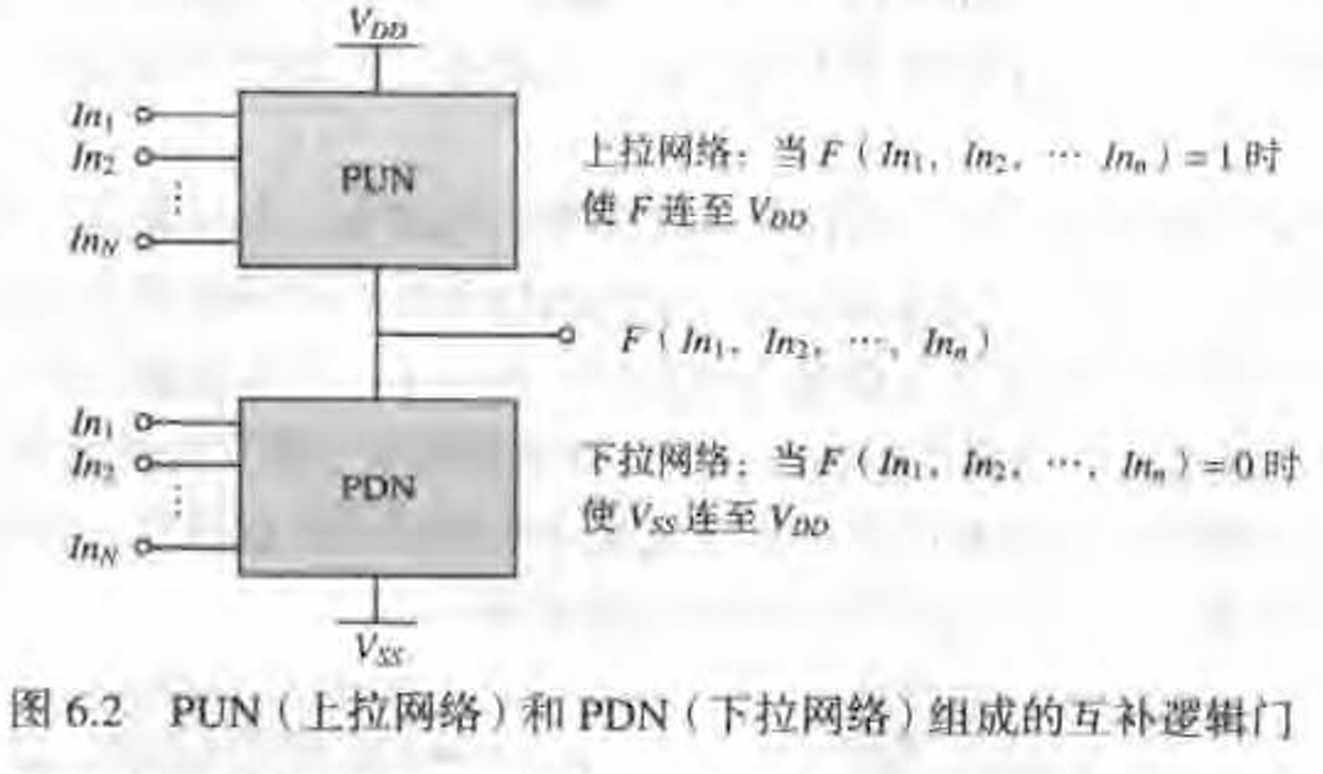
 (因为pmos载流子能力是nmos的1/2,所以是2倍),一些快速确定管子size的技巧:如果是串联那么size乘2,如果是并联,那么不变
(因为pmos载流子能力是nmos的1/2,所以是2倍),一些快速确定管子size的技巧:如果是串联那么size乘2,如果是并联,那么不变