参考:
PPT
半导体器件基础
BJT
- 双极晶体管,三个扩散区,两个 PN 结,发射极 (E) ,基极 (B) ,集电极 (C) 。
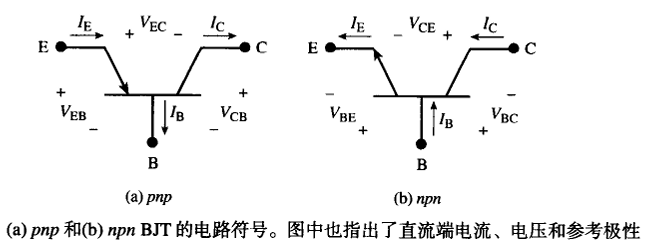
- 掺杂浓度:发射极浓度最高,基极次之,集电极浓度最低。BE 结正偏, BC 结反偏时,电子从发射极越过基极被电场扫到集电极。只有在发射极时,电子是多子,在基极电子是少子。为了让电子不与基极的空穴复合,基极的宽度会非常小。

- 考虑到 BJT 是少子器件,因此在对 BJT 进行分析时,也从少子的角度入手。

- BJT 工作特性与参数
- 电流与电压
- IE=IB+IC
- VEB+VBC+VCE=0
- 参数(PNP BJT)
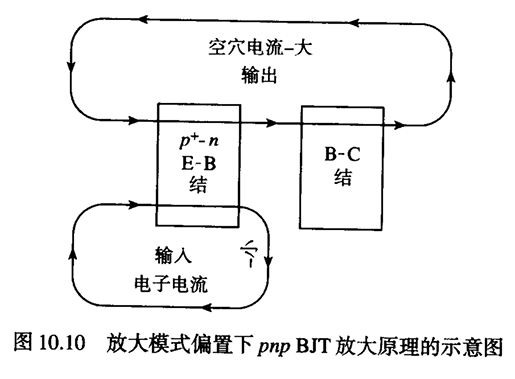
- 发射效率:γ=IEp+IEn(总发射极电流,在这里保持常数)IEp(少子的电流) 少子造成的电流占比越大,输出的电流就越大。0≤γ≤1 希望它尽可能接近 1 以获得增益。
- 基区输运系数: β∗=IEp(进入到基区的少数载流子)ICp(进入集电区的少数载流子) 是在基区复合的载流子数量的表征。0≤αT≤1 ,因为我们当然希望复合越少越好。
- 集电区倍增因子: α∗=IpC(集电极少子电流)IC(总集电极电流)
- 共基极电流放大系数: α=IEIC=γβ∗α∗
- 共射电流放大系数 β=IE−ICIC=1−αα
- 静态(直流)特性(发射极正偏,集电极反偏)
- 基本假设:
- 非简并,均匀掺杂(因此基区没有电场)的发射区,基区和集电区
- 稳态条件
- 准中性区小注入水平
- 晶体管内只有漂移、扩散、热复合-产生过程发生
- 耗尽区内热复合-产生可忽略
- 发射区-集电区准中性层宽度远大于这些区域的少数载流子扩散长度
- 思路:考虑到 BJT 是少子器件:少子浓度(特定点 → 少子分布) → 电流密度 → 电流-电压方程 → 从器件角度得到相关参数。
- 特定点(耗尽层边缘)的少子浓度:
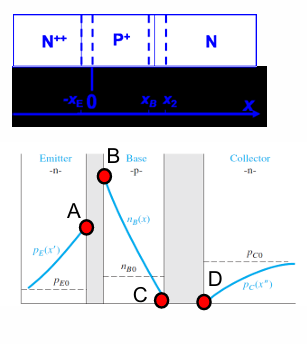 利用半导体物理知识总结之中的两个公式,可以求出特定点的少数载流子浓度。
利用半导体物理知识总结之中的两个公式,可以求出特定点的少数载流子浓度。
- pE(x=−xE)=pE0⋅exp(kTqVBE)
- nB(x=0)=nB0⋅exp(kTqVBE)
- nB(x=xB)=nB0⋅exp(kTqVBC)≈0
- pC(x=x2)=pC0⋅exp(kTqVBC)≈0
- 计算少子分布
- 基区:考虑少子分布计算的连续性方程:
∂t∂n=∂t∂ndrift+∂t∂ndiff+∂t∂nR−Gthermal+∂t∂n(light.etc)other
根据上面的条件和假设,以及基区少数载流子扩散长度 LB=Dn⋅τn ,得到: ∂x2∂2δn−LB2δn=0
求出通解并带入边界条件(除了上面求出的一个,还有 δnB(x=WB)=−nB0)并化简,可以得到:
nB(x)=δn(x)+nB0=nB0{[exp(kTqVBE)−1](1−WBx)−WBx+1}=nB0exp(kTqVBE)(1−WBx)
(在 WB≪LB 时)
- 可以发现,基区的少子分布呈线性关系。这里的物理含义为 WB≪LB (在化简时),也就是不考虑复合。如果把这一点代回连续性方程,也会得到类似的结果。
- 使用类似的办法,可以计算出发射区与集电区的少子分布。

- 下面,我们可以根据少子浓度的变化,计算其中的扩散电流,这里用到了扩散电流的计算(指菲克第一定律)。如果不考虑 Wb≪LB 的条件,会发现得到的结果与 VBE 无关。但是,在计算 BJT 的情况时,我们需要考虑这一点。因此有:Jn≈qDnLn,也即 Jnb(x)=−WbqDnbnb0exp(kTqVBE)
- 同理,可以算得其他地方的电流密度:

- 在这之后,我们可以根据计算得到的电流密度找到理想的电流电压方程了!真不容易!
- Je=Jpe(x=−x1)+Jnb(x=0)
Jc=Jpc(x=x2)+Jnb(x=Wb)
Jb=−(Jc+Je)
- IE :IE≡JeA=a11[exp(kTqVBE)−1]+a12[exp(kTqVBC)−1]
其中 a11=−qA[LBDnbnb0coth(LBWb)+LEDpepe0]
a12=LBqADnbnb0csch(LBWb)
- 基区较窄( Wb≈LB) 时:IE=−qA[WbDnbnb0+LEDpepe0]⋅exp(kTqVBE)=IS2⋅exp(VtVBE)
- IC :IC≡−JcA=a21[exp(kTqVBE)−1]+a22[exp(kTqVBC)−1]
其中 a21=LBqADnbnpb0csch(LBWb)=a12
a22=−qA[LBDnbnb0coth(LBWb)+LCDpcpc0]
- 基区较窄:α=γβ∗α∗≈(1−2LB2Wb2)/(1+ρsh,bρsh,e) 其中 Is=−WbqADnbnb0,热电压 Vt=qkT
- 总结:

- 最后一步是计算电流增益。
- 发射极注入效率:γ=JeJne=1+Ipe/Ine1=1+Ipe(−x1)/Inb(0)1
- 但这个公式过于理想,譬如 D ,N ,W 都无法测量。因此在实际情况之中,用方块的电阻来估计发射极的注入效率。(扩散系数 Dn=μnqkT ,电阻率 ρb=(qμnbnb)−1 ),从而得出 γ=[1+WBρbWEρe]−1 。
- 在实际的计算之中,将电阻简化为方块电阻:
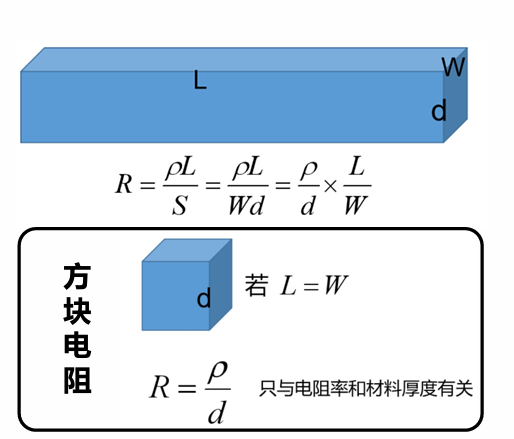 于是有 γ=(1+Rsh,bRsh,e)−1
于是有 γ=(1+Rsh,bRsh,e)−1
- 若 Wb≪LB 的条件不成立,那么γ=[1+DnbDpe⋅nb0pe0⋅LELB⋅tanh(LEWE)tanh(LBWb)]−1
- 基区传递系数:β∗=IneInc=Inb(0)Inb(Wb)=cosh(Wb/LB)1
- 若 Wb≪LB ,则:β∗=IneInc=Inb(0)Inb(Wb)=cosh(Wb/LB)1
- 分析时注意 LB=DBτ
- 共基极电流放大系数 α :α=γβ∗α∗≈(1−2LB2Wb2)/(1+ρsh,bρsh,e)
- 理想晶体管四种工作模式下的少子分布
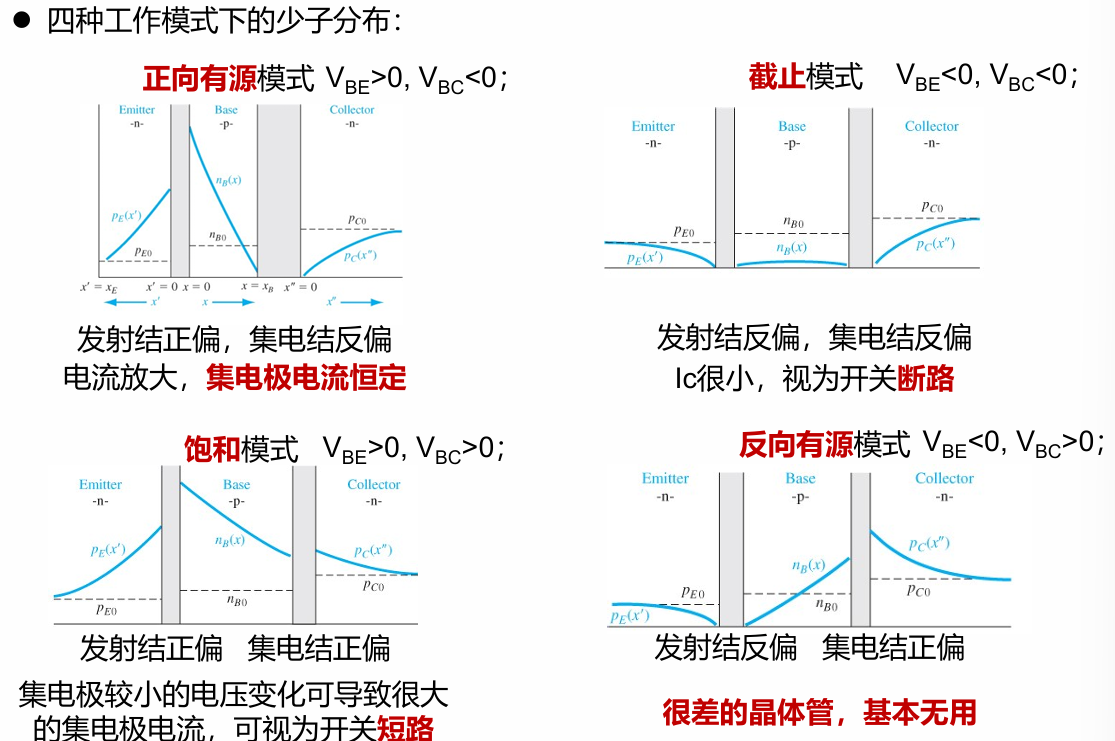
非理想特性
结面积导致的非理想效应
考虑发射效率 γ :
γ=JeJne=1+JneJpe1
这里直接用了 J 电流密度做比,而不是 I 做比,是因为默认两种电流流过的面积相等。然而发射区面积 = 集电区面积。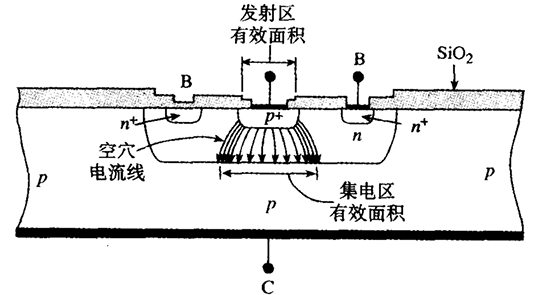
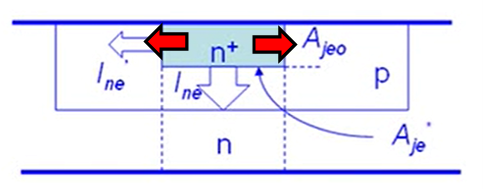 则上式变为 γ=Ine+Ipe′+Ine′Ine ,由 IneIpe′=JneAje∗Jpe(Aje∗+Aje0) ,代入可得 γ=(1+Aje∗Aje0)−1(1+JneJpe)−1
则上式变为 γ=Ine+Ipe′+Ine′Ine ,由 IneIpe′=JneAje∗Jpe(Aje∗+Aje0) ,代入可得 γ=(1+Aje∗Aje0)−1(1+JneJpe)−1
厄利效应(基区宽度调制效应)
随着 B-C 结反偏电压的增加,空间电荷区宽度增加,使得 xB 减小,这一减小,集电极电流也发生变化。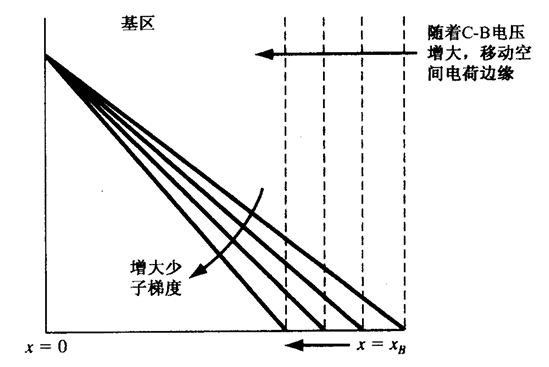 因而在共射电路之中可以很明显地观测到这样的非理想现象:
因而在共射电路之中可以很明显地观测到这样的非理想现象: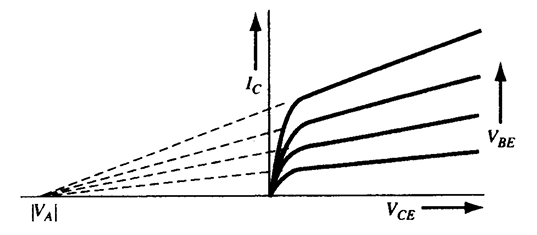 于是有
dVCEdIc=VCE+VAIc
于是有
dVCEdIc=VCE+VAIc
复合效应
之前的计算没考虑复合效应,现在考虑电子和空穴在 PN 结中的复合效应。复合率与电子寿命和空穴寿命的倒数成正比。 U=τn+τpnmax
势垒区: np=ni2eqVBE/KT ,开方后代入 U=2τnieqVBE/2kT
复合电流 Ire=U=2τqnieqVBE/2kTδe (发射结耗尽层宽度)
然后再考虑注入效率 γ ,这时考虑复合电流,有 γ=Ine+Ipe+IreIne
代入得: γ=[1+ρbρeLEWb+2ni⋅LB2NB⋅Wb⋅δeexp(2kT−qVBE)]−1
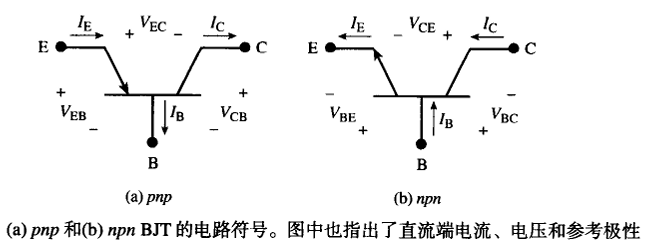


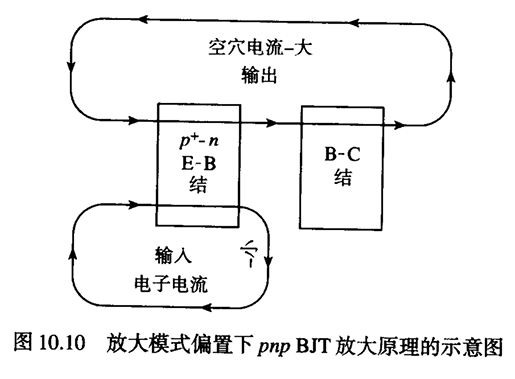
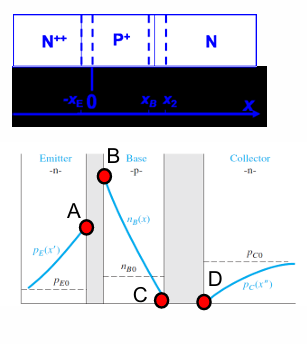 利用半导体物理知识总结之中的两个公式,可以求出特定点的少数载流子浓度。
利用半导体物理知识总结之中的两个公式,可以求出特定点的少数载流子浓度。



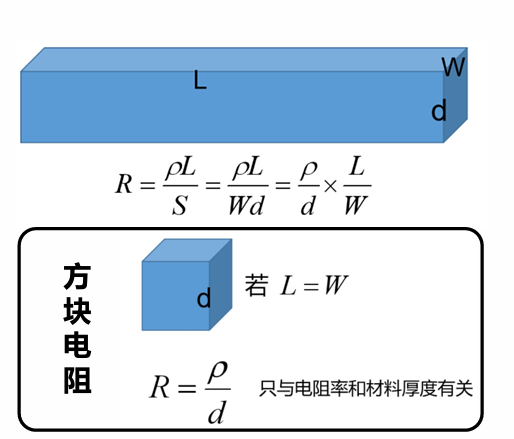 于是有
于是有 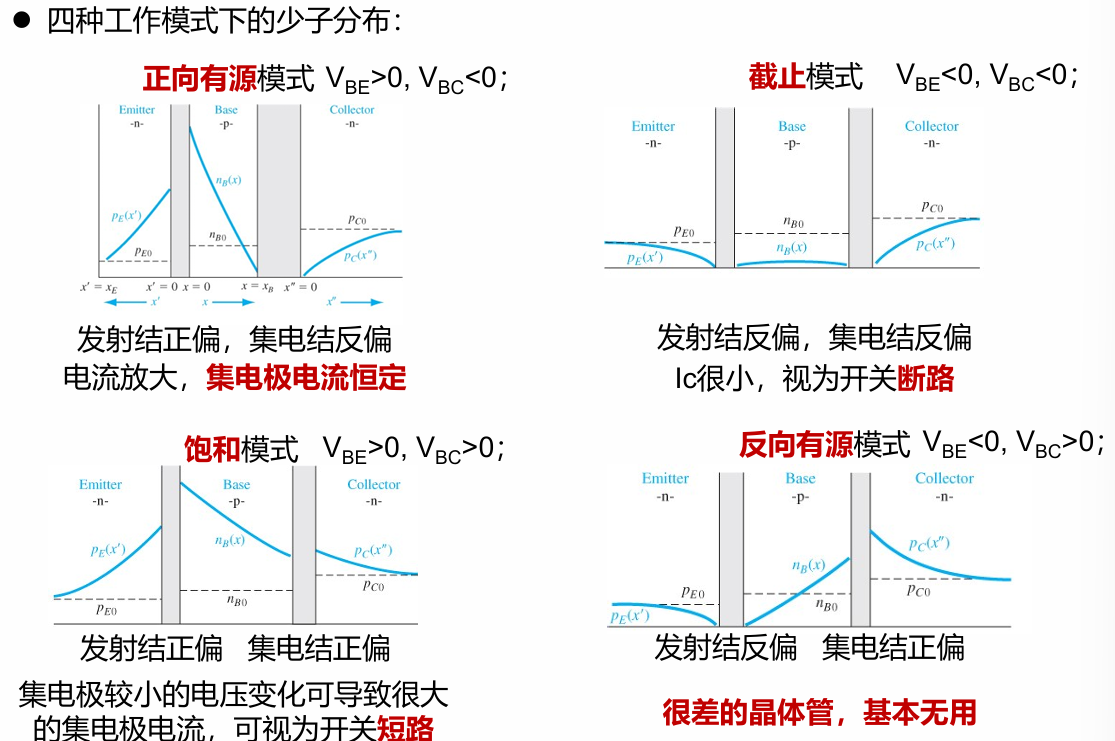
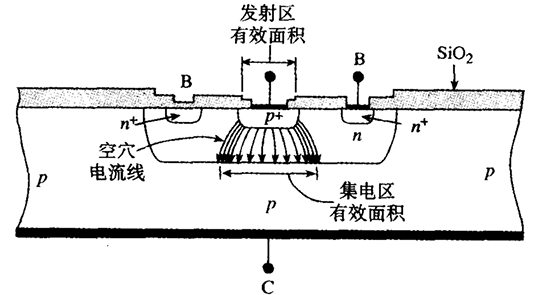
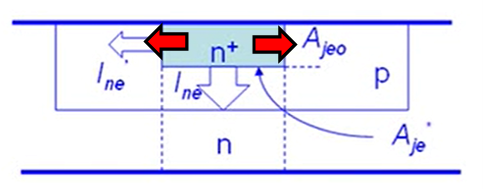 则上式变为 ,由 ,代入可得
则上式变为 ,由 ,代入可得 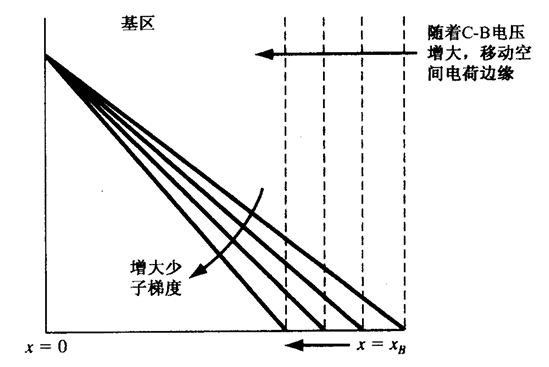 因而在共射电路之中可以很明显地观测到这样的非理想现象:
因而在共射电路之中可以很明显地观测到这样的非理想现象: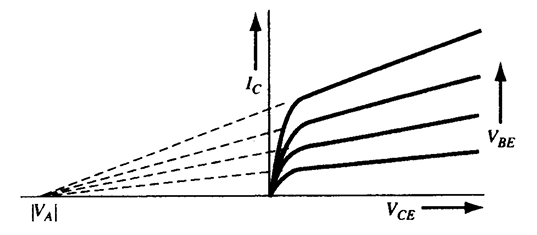 于是有
于是有